L'apparecchiatura per l'incollaggio dei wafer è un sistema ad alte prestazioni progettato per il packaging avanzato dei semiconduttori, la produzione di MEMS e l'integrazione dei semiconduttori di terza generazione. Supporta wafer da 2 a 12 pollici e consente l'incollaggio diretto a temperatura ambiente e l'incollaggio idrofilo, rendendolo particolarmente adatto per l'incollaggio di Si-Si, SiC-SiC e materiali eterogenei (Si-SiC, GaN, Zaffiro, ecc.).
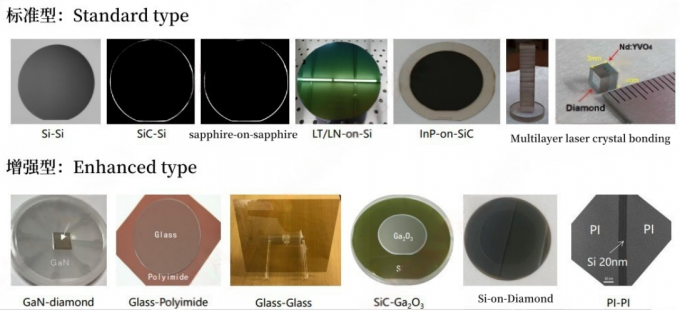
Progettato sia per gli ambienti di ricerca e sviluppo che per la produzione di massa, il sistema integra un allineamento ultra-preciso, un controllo della pressione e della temperatura ad anello chiuso e condizioni di incollaggio sotto vuoto spinto, garantendo un'elevata forza di incollaggio, un'eccellente uniformità dell'interfaccia e una bassa densità di difetti.
Caratteristiche principali
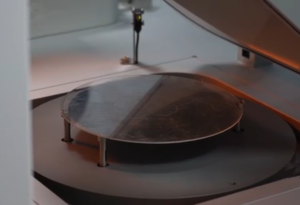 1. Tecnologia avanzata di incollaggio a temperatura ambiente
1. Tecnologia avanzata di incollaggio a temperatura ambiente
- Elimina lo stress termico e la deformazione dei wafer
- Consente l'incollaggio di materiali sensibili alla temperatura e dissimili
- Supporta l'incollaggio idrofilo e l'incollaggio attivato dal plasma
2. Allineamento di altissima precisione
- Precisione di allineamento del marchio: ≤ ±2 μm
- Precisione di allineamento dei bordi: ≤ ±50 μm
- Aggiornamento opzionale al sistema di allineamento submicronico
3. Elevata forza di adesione e qualità dell'interfaccia
- ≥ 2,0 J/m² (incollaggio diretto Si-Si a temperatura ambiente)
- Fino a ≥5 J/m² con attivazione della superficie del plasma
- Eccellente pulizia dell'interfaccia in condizioni UHV
4. Ampia compatibilità dei materiali
Supporta l'incollaggio di:
- Semiconduttori: Si, SiC, GaN, GaAs, InP
- Materiali ottici: Zaffiro, vetro
- Materiali funzionali: LiNbO₃, Diamante
5. Capacità di processo flessibile
- Dimensione del wafer: 2″ - 12″
- Compatibile con campioni di forma irregolare
- Moduli opzionali: preriscaldamento / ricottura (RT-500°C)
Specifiche tecniche
| Parametro | Specifiche |
|---|---|
| Metodi di incollaggio | Incollaggio diretto / Incollaggio attivato al plasma |
| Dimensione del wafer | 2″ - 12″ |
| Intervallo di pressione | 0 - 10 MPa |
| Forza massima | 100 kN |
| Intervallo di temperatura | Temperatura ambiente - 500°C (opzionale) |
| Livello di vuoto | ≤ 5 × 10-⁶ Torr |
| Precisione di allineamento | ≤ ±2 μm (segno), ≤ ±50 μm (bordo) |
| Forza di legame | ≥ 2,0 J/m² (RT Si-Si) |
 Sistema di controllo intelligente
Sistema di controllo intelligente
- HMI touchscreen di livello industriale
- Supporta la memorizzazione di oltre 50 ricette di processo
- Controllo ad anello chiuso pressione-temperatura in tempo reale
- Prestazioni di processo stabili e ripetibili
Sicurezza e affidabilità
- Tripla protezione di interblocco (pressione / temperatura / vuoto)
- Sistema di arresto di emergenza
- Progettato per la compatibilità con la camera bianca di Classe 100
Configurazioni opzionali
- Sistema di manipolazione robotizzata dei wafer
- Interfaccia di comunicazione SECS/GEM (pronta per l'integrazione in fabbrica)
- Modulo di ispezione in linea
- Unità di attivazione della superficie al plasma
Applicazioni tipiche
1. Imballaggio MEMS
Sigillatura ermetica per sensori come accelerometri e giroscopi
2. Integrazione IC 3D
Impilamento dei wafer per TSV e packaging avanzato
3. Dispositivi a semiconduttore composto
Incollaggio e trasferimento di strato dei dispositivi di potenza GaN / SiC
4. Sensori di immagine CMOS (CIS)
Incollaggio a bassa temperatura di wafer CMOS e substrati ottici
5. Biochip e microfluidica
Legame affidabile per i dispositivi lab-on-chip
Esempio di processo
Incollaggio di wafer LiNbO₃ - SiC (temperatura ambiente)
- Raggiunge un'interfaccia di incollaggio forte e uniforme
- Verificato mediante imaging TEM trasversale
- Adatto per applicazioni ad alta frequenza e optoelettroniche
DOMANDE E RISPOSTE
Q1: Perché scegliere l'incollaggio dei wafer a temperatura ambiente invece dell'incollaggio termico?
L'incollaggio a temperatura ambiente evita il disallineamento termico e le sollecitazioni, rendendolo ideale per i materiali eterogenei e migliorando la resa nel packaging avanzato.
D2: Quali materiali possono essere incollati?
Il sistema supporta un'ampia gamma di materiali, tra cui:
- Semiconduttori: Si, SiC, GaN
- Ossidi: SiO₂, LiNbO₃
- Metalli: Cu, Au
Perché scegliere questo sistema
- Prestazioni comprovate nella produzione di dispositivi di potenza SiC
- Resistenza all'incollaggio verificata tramite test di laboratorio e analisi TEM
- Progettato sia per gli istituti di ricerca che per le fabbriche industriali
- L'architettura modulare garantisce scalabilità e aggiornabilità a lungo termine






Recensioni
Ancora non ci sono recensioni.