晶圓接合設備是專為先進半導體封裝、微機電製造和第三代半導體整合所設計的高效能系統。它支援 2 吋至 12 吋晶圓,可在室溫下直接接合及親水性接合,特別適用於 Si-Si、SiC-SiC 及異質材料接合 (Si-SiC、GaN、藍寶石等)。.
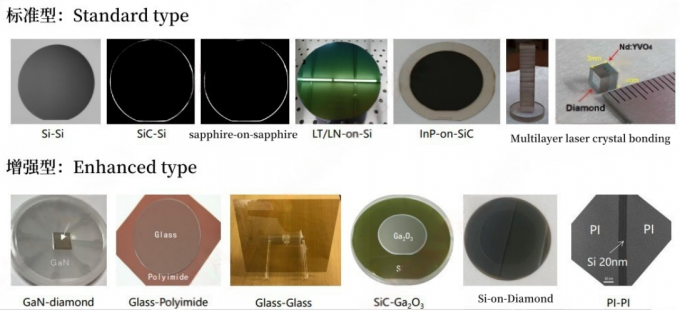
該系統專為研發環境和大量生產而設計,整合了超精密對位、閉環壓力和溫度控制,以及超高真空接合條件,可確保高接合強度、極佳的介面均勻性和低缺陷密度。.
主要功能
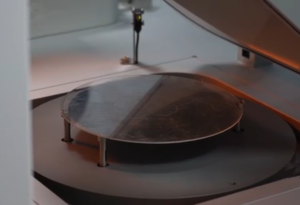 1.先進的室溫鍵合技術
1.先進的室溫鍵合技術
- 消除熱應力和晶圓翹曲
- 可粘接對溫度敏感的異種材料
- 支援親水性接合和電漿活化接合
2.超高精度對準
- 標記對準準確度: ≤ ±2 μm
- 邊緣對齊精確度: ≤ ±50 μm
- 可選擇升級至亞微米校準系統
3.高接合強度與介面品質
- ≥ 2.0 J/m² (室溫下的 Si-Si 直接接合)
- 等離子表面活化可達 ≥5 J/m²
- 在 UHV 條件下具有極佳的介面清潔度
4.廣泛的材料相容性
支援下列各項的接合
- 半導體:Si, SiC, GaN, GaAs, InP
- 光學材料:藍寶石、玻璃
- 功能性材料:LiNbO₃, 鑽石
5.彈性製程能力
- 晶圓尺寸:2″ - 12″
- 與不規則形狀的樣品相容
- 選購模組:預熱/退火 (RT-500°C)
技術規格
| 參數 | 規格 |
|---|---|
| 接合方法 | 直接接合 / 等離子活化接合 |
| 晶圓尺寸 | 2″ - 12″ |
| 壓力範圍 | 0 - 10 MPa |
| 最大壓力 | 100 kN |
| 溫度範圍 | 室溫 - 500°C(可選) |
| 真空度 | ≤ 5 × 10-⁶ Torr |
| 對準精度 | ≤ ±2 μm (Mark), ≤ ±50 μm (Edge) |
| 接合強度 | ≥ 2.0 J/m² (RT Si-Si) |
 智慧型控制系統
智慧型控制系統
- 工業級觸控式人機介面
- 支援 50+ 個製程配方儲存
- 即時壓力-溫度閉環控制
- 穩定且可重複的製程效能
安全性與可靠性
- 三重聯鎖保護(壓力/溫度/真空)
- 緊急停止系統
- 專為 100 級無塵室相容性而設計
可選配置
- 機器人晶圓處理系統
- SECS/GEM 通訊介面 (可與晶圓廠整合)
- 線上檢測模組
- 等離子表面活化裝置
典型應用
1.MEMS 封裝
加速度計和陀螺儀等感測器的密封設計
2.3D IC 整合
用於 TSV 和先進封裝的晶圓堆疊
3.複合半導體元件
GaN / SiC 功率元件接合和層轉換
4.CMOS 影像感測器 (CIS)
CMOS 晶圓與光學基板的低溫接合
5.生物晶片與微流體
適用於實驗室單晶片裝置的可靠接合
製程範例
LiNbO₃ - SiC 晶圓接合 (室溫)
- 達到堅固且均勻的接合介面
- 經橫斷面 TEM 成像驗證
- 適用於高頻與光電應用
問與答
Q1: 為何要選擇室溫晶片接合而非熱接合?
室溫接合可避免熱錯位和應力,因此非常適用於異質材料,並可提高先進封裝的良率。.
Q2: 哪些材料可以進行黏合?
本系統支援多種材料,包括
- 半導體:Si, SiC, GaN
- 氧化物:SiO₂、LiNbO₃
- 金屬:銅、金
為何選擇此系統
- 在 SiC 功率元件製造過程中經過驗證的效能
- 透過實驗室測試和 TEM 分析驗證接合強度
- 專為研究機構和工業晶圓廠設計
- 模組化架構可確保長期的可擴充性及可升級性






商品評價
目前沒有評價。