Das Wafer Bonding Equipment ist ein Hochleistungssystem, das für fortschrittliches Halbleiter-Packaging, MEMS-Fertigung und Halbleiterintegration der dritten Generation entwickelt wurde. Es unterstützt 2-Zoll- bis 12-Zoll-Wafer und ermöglicht das direkte Bonden bei Raumtemperatur und das hydrophile Bonden, wodurch es sich besonders für das Bonden von Si-Si, SiC-SiC und heterogenen Materialien (Si-SiC, GaN, Saphir usw.) eignet.
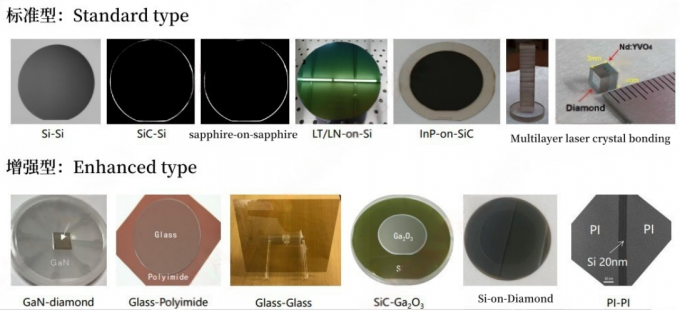
Das System wurde sowohl für F&E-Umgebungen als auch für die Massenproduktion entwickelt und umfasst eine hochpräzise Ausrichtung, eine geschlossene Druck- und Temperaturregelung sowie Ultrahochvakuum-Bonding-Bedingungen, die eine hohe Bondfestigkeit, eine ausgezeichnete Gleichmäßigkeit der Schnittstellen und eine geringe Fehlerdichte gewährleisten.
Wesentliche Merkmale
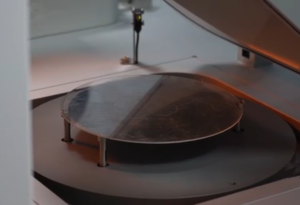 1. Fortschrittliche Raumtemperatur-Klebetechnologie
1. Fortschrittliche Raumtemperatur-Klebetechnologie
- Eliminiert thermischen Stress und Wafer-Verzug
- Ermöglicht das Verkleben von temperaturempfindlichen und unähnlichen Materialien
- Unterstützt hydrophiles Kleben und plasmaaktiviertes Kleben
2. Ultrahochpräzise Ausrichtung
- Genauigkeit der Markierungsausrichtung: ≤ ±2 μm
- Genauigkeit der Kantenausrichtung: ≤ ±50 μm
- Optionales Upgrade auf ein Submikron-Ausrichtungssystem
3. Hohe Bindungsstärke und Schnittstellenqualität
- ≥ 2,0 J/m² (direkte Si-Si-Bindung bei Raumtemperatur)
- Bis zu ≥5 J/m² mit Plasma-Oberflächenaktivierung
- Hervorragende Grenzflächensauberkeit unter UHV-Bedingungen
4. Breite Materialkompatibilität
Unterstützt das Kleben von:
- Halbleiter: Si, SiC, GaN, GaAs, InP
- Optische Materialien: Saphir, Glas
- Funktionelle Materialien: LiNbO₃, Diamant
5. Flexible Prozessfähigkeit
- Waffelgröße: 2″ - 12″
- Kompatibel mit unregelmäßig geformten Proben
- Optionale Module: Vorwärmen / Glühen (RT-500°C)
Technische Daten
| Parameter | Spezifikation |
|---|---|
| Bindungsmethoden | Direktes Kleben / Plasma-aktiviertes Kleben |
| Wafer Größe | 2″ - 12″ |
| Druckbereich | 0 - 10 MPa |
| Maximale Kraft | 100 kN |
| Temperaturbereich | Raumtemperatur - 500°C (optional) |
| Vakuum Niveau | ≤ 5 × 10-⁶ Torr |
| Ausrichtungsgenauigkeit | ≤ ±2 μm (Markierung), ≤ ±50 μm (Kante) |
| Stärke der Bindung | ≥ 2,0 J/m² (RT Si-Si) |
 Intelligentes Kontrollsystem
Intelligentes Kontrollsystem
- Industrietaugliches Touchscreen-HMI
- Unterstützt die Speicherung von mehr als 50 Prozessrezepten
- Druck-Temperatur-Regelung in Echtzeit
- Stabile und wiederholbare Prozessleistung
Sicherheit und Verlässlichkeit
- Dreifacher Verriegelungsschutz (Druck / Temperatur / Vakuum)
- Not-Aus-System
- Entwickelt für Reinraumkompatibilität der Klasse 100
Optionale Konfigurationen
- Robotersystem zur Handhabung von Wafern
- SECS/GEM-Kommunikationsschnittstelle (bereit zur Integration in die Fabrik)
- Inline-Inspektionsmodul
- Plasma-Oberflächenaktivierungsgerät
Typische Anwendungen
1. MEMS-Verpackung
Hermetische Abdichtung für Sensoren wie Beschleunigungsmesser und Gyroskope
2. 3D-IC-Integration
Wafer Stacking für TSV und Advanced Packaging
3. Verbindungs-Halbleiterbauelemente
GaN/SiC-Leistungsbauelemente: Bonden und Schichtübertragung
4. CMOS-Bildsensoren (CIS)
Niedertemperatur-Bonden von CMOS-Wafern und optischen Substraten
5. Biochips und Mikrofluidik
Zuverlässiges Bonding für Lab-on-chip-Geräte
Beispiel für einen Prozess
LiNbO₃ - SiC Wafer Bonding (Raumtemperatur)
- Erzielt eine starke und einheitliche Klebeschicht
- Verifiziert durch TEM-Bildgebung im Querschnitt
- Geeignet für Hochfrequenz- und optoelektronische Anwendungen
FRAGEN UND ANTWORTEN
Q1: Warum sollte man sich für das Bonden von Wafern bei Raumtemperatur und nicht für das thermische Bonden entscheiden?
Durch das Bonden bei Raumtemperatur werden thermische Fehlanpassungen und Spannungen vermieden, wodurch es sich ideal für heterogene Materialien eignet und die Ausbeute bei modernen Verpackungen verbessert.
F2: Welche Materialien können verklebt werden?
Das System unterstützt eine breite Palette von Materialien, darunter:
- Halbleiter: Si, SiC, GaN
- Oxide: SiO₂, LiNbO₃
- Metalle: Cu, Au
Warum dieses System wählen?
- Bewährte Leistung bei der Herstellung von SiC-Leistungsbauelementen
- Überprüfte Klebekraft durch Labortests und TEM-Analyse
- Konzipiert sowohl für Forschungsinstitute als auch für industrielle Fabriken
- Modulare Architektur gewährleistet langfristige Skalierbarkeit und Aufrüstbarkeit






Rezensionen
Es gibt noch keine Rezensionen.