웨이퍼 본딩 장비는 첨단 반도체 패키징, MEMS 제조 및 3세대 반도체 통합을 위해 설계된 고성능 시스템입니다. 2인치에서 12인치 웨이퍼를 지원하며 상온 직접 본딩 및 친수성 본딩이 가능하여 특히 Si-Si, SiC-SiC 및 이종 재료 본딩(Si-SiC, GaN, 사파이어 등)에 적합합니다.
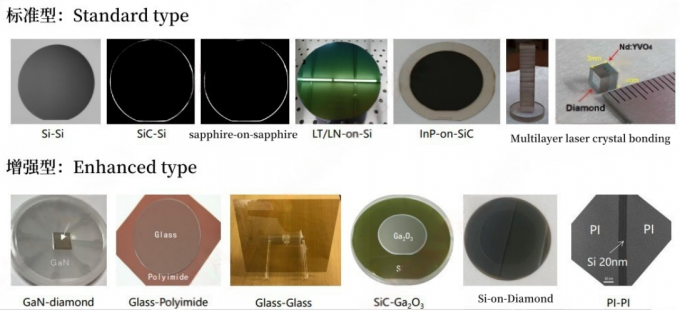
R&D 환경과 대량 생산 모두를 위해 설계된 이 시스템은 초정밀 정렬, 폐쇄 루프 압력 및 온도 제어, 초고진공 본딩 조건을 통합하여 높은 접착 강도, 우수한 인터페이스 균일성, 낮은 결함 밀도를 보장합니다.
주요 기능
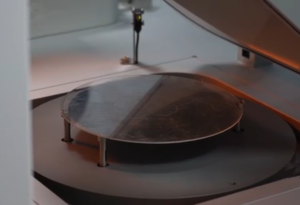 1. 고급 상온 본딩 기술
1. 고급 상온 본딩 기술
- 열 응력 및 웨이퍼 뒤틀림 제거
- 온도에 민감하고 서로 다른 재료의 접착 가능
- 친수성 결합 및 플라즈마 활성화 결합 지원
2. 초정밀 정렬
- 마크 정렬 정확도: ≤ ±2μm
- 에지 정렬 정확도: ≤ ±50μm
- 서브미크론 정렬 시스템으로 업그레이드(옵션)
3. 높은 결합 강도 및 인터페이스 품질
- ≥ 2.0 J/m² 이상(실온에서 Si-Si 직접 결합)
- 플라즈마 표면 활성화로 최대 ≥5 J/m² 달성
- UHV 조건에서 뛰어난 인터페이스 청결도
4. 폭넓은 소재 호환성
본딩을 지원합니다:
- 반도체 Si, SiC, GaN, GaAs, InP
- 광학 재료: 사파이어, 유리
- 기능성 소재: LiNbO₃, 다이아몬드
5. 유연한 프로세스 기능
- 웨이퍼 크기: 2인치 - 12인치
- 불규칙한 모양의 샘플과 호환
- 옵션 모듈: 예열/어닐링(RT-500°C)
기술 사양
| 매개변수 | 사양 |
|---|---|
| 본딩 방법 | 직접 결합 / 플라즈마 활성화 결합 |
| 웨이퍼 크기 | 2″ - 12″ |
| 압력 범위 | 0 - 10 MPa |
| 최대 힘 | 100 kN |
| 온도 범위 | 실내 온도 - 500°C(옵션) |
| 진공 레벨 | ≤ 5 × 10-⁶ Torr |
| 정렬 정확도 | ≤ ±2μm(마크), ≤ ±50μm(가장자리) |
| 결합 강도 | ≥ 2.0 J/m²(RT Si-Si) |
 지능형 제어 시스템
지능형 제어 시스템
- 산업용 등급 터치스크린 HMI
- 50개 이상의 프로세스 레시피 저장 지원
- 실시간 압력-온도 폐쇄 루프 제어
- 안정적이고 반복 가능한 프로세스 성능
안전 및 신뢰성
- 3중 인터록 보호(압력/온도/진공)
- 비상 정지 시스템
- 클래스 100 클린룸 호환성을 위한 설계
선택적 구성
- 로봇 웨이퍼 처리 시스템
- SECS/GEM 통신 인터페이스(팹 통합 준비 완료)
- 인라인 검사 모듈
- 플라즈마 표면 활성화 장치
일반적인 애플리케이션
1. MEMS 패키징
가속도계 및 자이로스코프와 같은 센서를 위한 밀폐 밀봉
2. 3D IC 통합
TSV 및 첨단 패키징을 위한 웨이퍼 적층
3. 화합물 반도체 소자
GaN/SiC 전력 소자 본딩 및 층 이동
4. CMOS 이미지 센서(CIS)
CMOS 웨이퍼 및 광학 기판의 저온 접착
5. 바이오칩 및 마이크로유체학
랩온칩 디바이스를 위한 안정적인 본딩
프로세스 예시
LiNbO₃ - SiC 웨이퍼 본딩(상온)
- 강력하고 균일한 본딩 인터페이스 구현
- 단면 TEM 이미징을 통한 검증
- 고주파 및 광전자 애플리케이션에 적합
Q&A
Q1: 열 본딩 대신 상온 웨이퍼 본딩을 선택하는 이유는 무엇인가요?
상온 접착은 열 불일치 및 응력을 방지하여 이질적인 재료에 이상적이며 고급 패키징의 수율을 향상시킵니다.
Q2: 어떤 재료를 접착할 수 있나요?
이 시스템은 다음과 같은 다양한 자료를 지원합니다:
- 반도체 Si, SiC, GaN
- 산화물 SiO₂, LiNbO₃
- 금속: Cu, Au
이 시스템을 선택해야 하는 이유
- SiC 전력 소자 제조에서 입증된 성능
- 실험실 테스트 및 TEM 분석을 통한 결합 강도 검증
- 연구 기관과 산업 팹 모두를 위한 설계
- 모듈식 아키텍처로 장기적인 확장성 및 업그레이드 가능성 보장






상품평
아직 상품평이 없습니다.