![]() L'apparecchiatura laser microfluidica utilizza la tecnologia laser a microgetto avanzata per fornire una lavorazione ad alta precisione e a basso danno termico per wafer di semiconduttori e altri materiali duri, fragili o ad ampio bandgap. Combinando un getto d'acqua sub-micronico con un raggio laser, il sistema guida l'energia laser con precisione sulla superficie del pezzo, mentre il flusso d'acqua raffredda e rimuove continuamente i detriti. Questa tecnologia risolve efficacemente le sfide comuni della lavorazione laser e meccanica convenzionale, tra cui danni termici, microfratture, contaminazione, conicità e deformazione.
L'apparecchiatura laser microfluidica utilizza la tecnologia laser a microgetto avanzata per fornire una lavorazione ad alta precisione e a basso danno termico per wafer di semiconduttori e altri materiali duri, fragili o ad ampio bandgap. Combinando un getto d'acqua sub-micronico con un raggio laser, il sistema guida l'energia laser con precisione sulla superficie del pezzo, mentre il flusso d'acqua raffredda e rimuove continuamente i detriti. Questa tecnologia risolve efficacemente le sfide comuni della lavorazione laser e meccanica convenzionale, tra cui danni termici, microfratture, contaminazione, conicità e deformazione.
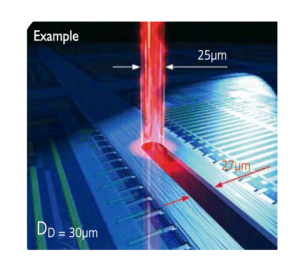 Caratteristiche principali
Caratteristiche principali
- Tipo di laser: Laser Nd:YAG a stato solido pompato a diodi, lunghezza d'onda 532/1064 nm, larghezza d'impulso in μs/ns, potenza media 10-200 W
- Sistema a getto d'acqua: Acqua filtrata deionizzata a bassa pressione; il microgetto ultrafine consuma solo 1 L/h a 300 bar, forza trascurabile (<0,1 N)
- Ugello: Zaffiro o diamante, diametro 30-150 μm per una guida laser precisa
- Sistema ausiliario: Le pompe ad alta pressione e le unità di trattamento dell'acqua garantiscono prestazioni stabili del getto
- Precisione: Precisione di posizionamento ±5 μm, precisione di posizionamento ripetuto ±2 μm
- Capacità di elaborazione: Rugosità superficiale Ra ≤1,2-1,6 μm, velocità di taglio lineare ≥50 mm/s, velocità di apertura ≥1,25 mm/s, taglio della circonferenza ≥6 mm/s
Specifiche tecniche
| Specifiche | Opzione 1 | Opzione 2 |
|---|---|---|
| Volume del piano di lavoro (mm) | 300×300×150 | 400×400×200 |
| Asse lineare XY | Motore lineare | Motore lineare |
| Asse lineare Z | 150 | 200 |
| Precisione di posizionamento (μm) | ±5 | ±5 |
| Precisione di posizionamento ripetuta (μm) | ±2 | ±2 |
| Accelerazione (G) | 1 | 0.29 |
| Controllo numerico | Asse 3 / 3+1 / 3+2 | Asse 3 / 3+1 / 3+2 |
| Lunghezza d'onda (nm) | 532/1064 | 532/1064 |
| Potenza nominale (W) | 50/100/200 | 50/100/200 |
| Pressione del getto d'acqua (bar) | 50-100 | 50-600 |
| Dimensione ugello (μm) | 30-150 | 30-150 |
| Dimensioni della macchina (mm) | 1445×1944×2260 | 1700×1500×2120 |
| Peso (T) | 2.5 | 3 |
Applicazioni
- Taglio e cubettatura dei wafer
- Materiali: Silicio (Si), carburo di silicio (SiC), nitruro di gallio (GaN) e altri wafer duri/fragili
- Vantaggi: Sostituisce i tradizionali dischi diamantati, riduce la rottura dei bordi (20 μm), aumenta la velocità di taglio di 30%, consente una cubettatura invisibile per wafer ultrasottili (<50 μm).
- Perforazione di trucioli e lavorazione di microfori
- Applicazioni: Foratura di vie passanti per il silicio (TSV), array di microfori termici per dispositivi di potenza
- Caratteristiche: Apertura 10-200 μm, rapporto profondità/larghezza fino a 10:1, rugosità superficiale Ra <0,5 μm
- Imballaggio avanzato
- Applicazioni: Apertura finestra RDL, confezionamento a livello di wafer (Fan-Out WLP)
- Vantaggi: Evita le sollecitazioni meccaniche, migliora la resa a >99,5%
- Lavorazione dei semiconduttori composti
- Materiali: GaN, SiC e altri semiconduttori a banda larga
- Caratteristiche: Incisione della tacca del gate, ricottura laser, controllo preciso dell'energia per evitare la decomposizione termica.
- Riparazione dei difetti e messa a punto
- Applicazioni: Fusione laser per circuiti di memoria, messa a punto di array di microlenti per sensori ottici
- Precisione: Controllo dell'energia ±1%, errore di posizionamento di riparazione <0,1 μm
![]()
Punti salienti e vantaggi
- La lavorazione a freddo, pulita e controllata riduce al minimo i danni da calore, le microfratture e le conicità
- Il getto d'acqua ultrafine assicura una guida laser precisa e un'efficiente rimozione dei detriti
- Adatto per materiali duri, fragili e trasparenti come SiC, GaN, diamante, LTCC e cristalli fotovoltaici.
- Compatibile con la produzione di semiconduttori ad alta precisione, l'imballaggio avanzato, i componenti aerospaziali e la microelettronica.
- Migliora la resa, riduce gli scarti di materiale e ne preserva le proprietà.
Certificazione e conformità
- Conforme alla direttiva RoHS
- Progettato per applicazioni di semiconduttori ad alta precisione
- Supporta l'elaborazione riproducibile, ripetibile e automatizzata
FAQ
1. Quali tipi di materiali possono essere lavorati con le apparecchiature laser microfluidiche?
La tecnologia laser microfluidica è in grado di lavorare con precisione materiali semiconduttori duri, fragili e ad ampio bandgap, tra cui silicio (Si), carburo di silicio (SiC), nitruro di gallio (GaN), diamante, substrati ceramici di carbonio LTCC, cristalli fotovoltaici e altri materiali avanzati. È ideale per le applicazioni che richiedono un danno termico minimo e un'elevata qualità superficiale.
2. In che modo la tecnologia laser a microgetto migliora la produzione di wafer di semiconduttori?
Combinando un getto d'acqua sub-micronico con un raggio laser, la tecnologia raggiunge una precisione sub-micronica, riducendo al minimo le zone colpite dal calore, la contaminazione e la rottura dei bordi. Sostituisce le tradizionali lame meccaniche per la cubettatura, la foratura e la microstrutturazione, migliorando la resa e riducendo gli scarti di materiale.
3. Per quali applicazioni sono più adatte le apparecchiature laser microfluidiche?
Questa apparecchiatura è ampiamente utilizzata in:
- Taglio a cubetti di wafer e taglio a cubetti di wafer ultrasottili (<50 μm)
- Foratura e array di microfori attraverso il silicio (TSV) per circuiti integrati 3D e dispositivi di potenza
- Confezionamento avanzato, come l'apertura della finestra RDL, il confezionamento a livello di wafer (Fan-Out WLP) e l'incisione/ricottura laser del gate per semiconduttori GaN e SiC




Recensioni
Ancora non ci sono recensioni.