El equipo de unión de obleas es un sistema de alto rendimiento diseñado para el envasado avanzado de semiconductores, la fabricación de MEMS y la integración de semiconductores de tercera generación. Admite obleas de 2 a 12 pulgadas y permite la unión directa a temperatura ambiente y la unión hidrofílica, por lo que resulta especialmente adecuado para la unión de Si-Si, SiC-SiC y materiales heterogéneos (Si-SiC, GaN, zafiro, etc.).
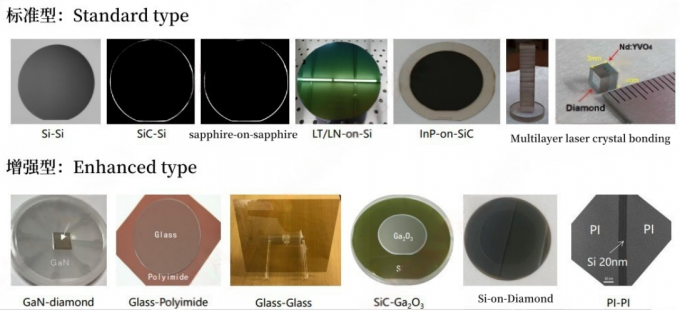
Diseñado tanto para entornos de I+D como para producción en serie, el sistema integra alineación de ultraprecisión, control de presión y temperatura en bucle cerrado y condiciones de unión en vacío ultraalto, lo que garantiza una alta resistencia de unión, una excelente uniformidad de la interfaz y una baja densidad de defectos.
Características principales
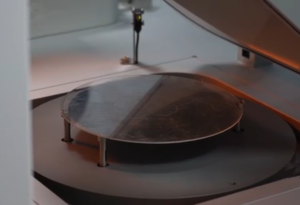 1. Tecnología avanzada de unión a temperatura ambiente
1. Tecnología avanzada de unión a temperatura ambiente
- Elimina el estrés térmico y el alabeo de la oblea
- Permite unir materiales sensibles a la temperatura y disímiles
- Favorece la adhesión hidrófila y la adhesión activada por plasma
2. Alineación de alta precisión
- Precisión de alineación de la marca: ≤ ±2 μm
- Precisión de alineación de bordes: ≤ ±50 μm
- Actualización opcional al sistema de alineación submicrónica
3. Alta resistencia de adhesión y calidad de la interfaz
- ≥ 2,0 J/m² (unión directa Si-Si a temperatura ambiente)
- Hasta ≥5 J/m² con activación de la superficie del plasma
- Excelente limpieza de la interfaz en condiciones UHV
4. Amplia compatibilidad de materiales
Admite la unión de:
- Semiconductores: Si, SiC, GaN, GaAs, InP
- Materiales ópticos: Zafiro, Cristal
- Materiales funcionales: LiNbO₃, Diamante
5. Capacidad de proceso flexible
- Tamaño de la oblea: 2″ - 12″.
- Compatible con muestras de forma irregular
- Módulos opcionales: precalentamiento / recocido (RT-500°C)
Especificaciones técnicas
| Parámetro | Especificación |
|---|---|
| Métodos de adhesión | Adhesión directa / adhesión activada por plasma |
| Tamaño de la oblea | 2″ - 12″ |
| Rango de presión | 0 - 10 MPa |
| Fuerza máxima | 100 kN |
| Temperatura | Temperatura ambiente - 500°C (opcional) |
| Nivel de vacío | ≤ 5 × 10-⁶ Torr |
| Precisión de alineación | ≤ ±2 μm (Marca), ≤ ±50 μm (Borde) |
| Fuerza de adhesión | ≥ 2,0 J/m² (RT Si-Si) |
 Sistema de control inteligente
Sistema de control inteligente
- Pantalla táctil industrial HMI
- Admite el almacenamiento de más de 50 recetas de procesos
- Control en bucle cerrado de presión-temperatura en tiempo real
- Rendimiento estable y repetible del proceso
Seguridad y fiabilidad
- Triple protección de enclavamiento (presión / temperatura / vacío)
- Sistema de parada de emergencia
- Diseñado para ser compatible con salas blancas de clase 100
Configuraciones opcionales
- Sistema robotizado de manipulación de obleas
- Interfaz de comunicación SECS/GEM (lista para la integración en fábrica)
- Módulo de inspección en línea
- Unidad de activación de la superficie de plasma
Aplicaciones típicas
1. Embalaje de MEMS
Sellado hermético para sensores como acelerómetros y giroscopios
2. Integración de CI en 3D
Apilado de obleas para TSV y envasado avanzado
3. Dispositivos semiconductores compuestos
Unión de dispositivos de potencia GaN / SiC y transferencia de capas
4. Sensores de imagen CMOS (CIS)
Unión a baja temperatura de obleas CMOS y sustratos ópticos
5. Biochips y microfluidos
Unión fiable para dispositivos lab-on-chip
Ejemplo de proceso
Unión de obleas de LiNbO₃ - SiC (temperatura ambiente)
- Consigue una interfaz de unión fuerte y uniforme
- Verificado mediante imágenes TEM transversales
- Adecuado para aplicaciones de alta frecuencia y optoelectrónicas
PREGUNTAS Y RESPUESTAS
P1: ¿Por qué elegir el pegado de obleas a temperatura ambiente en lugar del pegado térmico?
La unión a temperatura ambiente evita desajustes térmicos y tensiones, por lo que es ideal para materiales heterogéneos y mejora el rendimiento en envases avanzados.
P2: ¿Qué materiales pueden adherirse?
El sistema admite una amplia gama de materiales:
- Semiconductores: Si, SiC, GaN
- Óxidos: SiO₂, LiNbO₃
- Metales: Cu, Au
Por qué elegir este sistema
- Rendimiento demostrado en la fabricación de dispositivos de potencia de SiC
- Resistencia de adhesión verificada mediante pruebas de laboratorio y análisis TEM.
- Diseñado tanto para institutos de investigación como para fábricas industriales
- La arquitectura modular garantiza la escalabilidad y capacidad de actualización a largo plazo






Valoraciones
No hay valoraciones aún.