![]() Mikrofluidik-Laseranlagen nutzen die fortschrittliche Mikrojet-Lasertechnologie für die hochpräzise Bearbeitung von Halbleiterwafern und anderen harten, spröden oder breitbandigen Materialien mit geringer thermischer Schädigung. Durch die Kombination eines Submikrometer-Wasserstrahls mit einem Laserstrahl lenkt das System die Laserenergie präzise auf die Werkstückoberfläche, während der Wasserstrahl kontinuierlich kühlt und Ablagerungen entfernt. Mit dieser Technologie lassen sich die üblichen Probleme der konventionellen Laserbearbeitung und der mechanischen Bearbeitung, wie thermische Schäden, Mikrorisse, Verunreinigungen, Verjüngung und Verformung, wirksam lösen.
Mikrofluidik-Laseranlagen nutzen die fortschrittliche Mikrojet-Lasertechnologie für die hochpräzise Bearbeitung von Halbleiterwafern und anderen harten, spröden oder breitbandigen Materialien mit geringer thermischer Schädigung. Durch die Kombination eines Submikrometer-Wasserstrahls mit einem Laserstrahl lenkt das System die Laserenergie präzise auf die Werkstückoberfläche, während der Wasserstrahl kontinuierlich kühlt und Ablagerungen entfernt. Mit dieser Technologie lassen sich die üblichen Probleme der konventionellen Laserbearbeitung und der mechanischen Bearbeitung, wie thermische Schäden, Mikrorisse, Verunreinigungen, Verjüngung und Verformung, wirksam lösen.
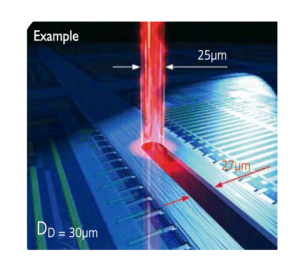 Wesentliche Merkmale
Wesentliche Merkmale
- Laser-Typ: Diodengepumpter Nd:YAG-Festkörperlaser, Wellenlänge 532/1064 nm, Pulsbreite in μs/ns, mittlere Leistung 10-200 W
- Wasserstrahl-System: Niederdruck, deionisiertes, gefiltertes Wasser; ultrafeiner Mikrostrahl verbraucht nur 1 L/h bei 300 bar, vernachlässigbare Kraft (<0,1 N)
- Düse: Saphir oder Diamant, 30-150 μm Durchmesser für präzise Laserführung
- Zusätzliches System: Hochdruckpumpen und Wasseraufbereitungsanlagen sorgen für eine stabile Strahlleistung
- Präzision: Positioniergenauigkeit ±5 μm, wiederholte Positioniergenauigkeit ±2 μm
- Verarbeitungskapazität: Oberflächenrauhigkeit Ra ≤1,2-1,6 μm, lineare Schnittgeschwindigkeit ≥50 mm/s, Öffnungsgeschwindigkeit ≥1,25 mm/s, Umfangsschneiden ≥6 mm/s
Technische Daten
| Spezifikation | Option 1 | Option 2 |
|---|---|---|
| Arbeitsplatte Volumen (mm) | 300×300×150 | 400×400×200 |
| Linear-Achse XY | Linearmotor | Linearmotor |
| Linear-Achse Z | 150 | 200 |
| Positionierungsgenauigkeit (μm) | ±5 | ±5 |
| Wiederholte Positionierungsgenauigkeit (μm) | ±2 | ±2 |
| Beschleunigung (G) | 1 | 0.29 |
| Numerische Steuerung | 3 Achsen / 3+1 / 3+2 Achsen | 3 Achsen / 3+1 / 3+2 Achsen |
| Wellenlänge (nm) | 532/1064 | 532/1064 |
| Nennleistung (W) | 50/100/200 | 50/100/200 |
| Wasserstrahldruck (bar) | 50-100 | 50-600 |
| Düsengröße (μm) | 30-150 | 30-150 |
| Abmessungen der Maschine (mm) | 1445×1944×2260 | 1700×1500×2120 |
| Gewicht (T) | 2.5 | 3 |
Anwendungen
- Würfeln und Schneiden von Wafern
- Werkstoffe: Silizium (Si), Siliziumkarbid (SiC), Galliumnitrid (GaN) und andere harte/spröde Wafer
- Vorteile: Ersetzt herkömmliche Diamantklingen, reduziert Kantenbruch (20 μm), erhöht die Schnittgeschwindigkeit um 30%, ermöglicht Stealth Dicing für ultra-dünne Wafer (<50 μm)
- Spänebohren und Mikrolochbearbeitung
- Anwendungen: Bohren von Through-Silicon-Vias (TSV), thermische Mikrolochanordnungen für Leistungsbauelemente
- Merkmale: Apertur 10-200 μm, Tiefen-/Breitenverhältnis bis zu 10:1, Oberflächenrauheit Ra <0,5 μm
- Fortschrittliche Verpackung
- Anwendungen: RDL-Fensteröffnung, Wafer-Level-Packaging (Fan-Out WLP)
- Vorteile: Vermeidet mechanische Belastung, verbessert die Ausbeute auf >99,5%
- Verarbeitung von Verbindungshalbleitern
- Werkstoffe: GaN, SiC und andere Halbleiter mit großer Bandlücke
- Merkmale: Ätzen von Gate-Notches, Laser-Glühen, präzise Energiekontrolle zur Vermeidung thermischer Zersetzung
- Defektreparatur & Feinabstimmung
- Anwendungen: Laserschmelzen für Speicherschaltungen, Abstimmung von Mikrolinsenarrays für optische Sensoren
- Genauigkeit: Energieregelung ±1%, Reparaturpositionierungsfehler <0,1 μm
![]()
Highlights & Vorteile
- Kalte, saubere und kontrollierte Verarbeitung minimiert Hitzeschäden, Mikrorisse und Verjüngung
- Ultrafeiner Wasserstrahl sorgt für präzise Laserführung und effiziente Schmutzentfernung
- Geeignet für harte, spröde und transparente Materialien wie SiC, GaN, Diamant, LTCC und photovoltaische Kristalle
- Kompatibel mit hochpräziser Halbleiterfertigung, fortschrittlichem Packaging, Luft- und Raumfahrtkomponenten und Mikroelektronik
- Verbessert die Ausbeute, reduziert den Materialabfall und bewahrt die Materialeigenschaften
Zertifizierung und Konformität
- RoHS-konform
- Entwickelt für hochpräzise Halbleiteranwendungen
- Unterstützt eine reproduzierbare, wiederholbare und automatisierte Verarbeitung
FAQ
1. Welche Arten von Materialien können mit mikrofluidischen Lasergeräten bearbeitet werden?
Die mikrofluidische Lasertechnologie kann harte, spröde und breitbandige Halbleitermaterialien präzise bearbeiten, darunter Silizium (Si), Siliziumkarbid (SiC), Galliumnitrid (GaN), Diamant, LTCC-Kohlenstoffkeramiksubstrate, Photovoltaikkristalle und andere moderne Materialien. Es ist ideal für Anwendungen, die minimale thermische Schäden und eine hohe Oberflächenqualität erfordern.
2. Wie verbessert die Mikrojet-Lasertechnologie die Herstellung von Halbleiterwafern?
Durch die Kombination eines Submikrometer-Wasserstrahls mit einem Laserstrahl erreicht die Technologie eine Genauigkeit im Submikrometerbereich und minimiert gleichzeitig Wärmeeinflusszonen, Verschmutzung und Kantenbruch. Sie ersetzt herkömmliche mechanische Klingen für das Trennen, Bohren und die Mikrostrukturierung, verbessert die Ausbeute und reduziert den Materialabfall.
3. Für welche Anwendungen sind mikrofluidische Lasergeräte am besten geeignet?
Dieses Gerät ist weit verbreitet in:
- Wafer-Dicing und Stealth-Dicing von ultradünnen Wafern (<50 μm)
- TSV-Bohrungen (Through-Silicon-Via) und Mikrobohrungen für 3D-ICs und Leistungsbauelemente
- Advanced Packaging, wie RDL-Fensteröffnung, Wafer-Level-Packaging (Fan-Out WLP) und Gate-Ätzen/Lasertempern für GaN- und SiC-Halbleiter




Rezensionen
Es gibt noch keine Rezensionen.