Wafer Bonding Equipment är ett högpresterande system som är konstruerat för avancerad halvledarförpackning, MEMS-tillverkning och tredje generationens halvledarintegration. Den stöder 2-tums till 12-tums wafers och möjliggör direkt bondning i rumstemperatur och hydrofil bondning, vilket gör den särskilt lämplig för Si-Si, SiC-SiC och bondning av heterogena material (Si-SiC, GaN, Sapphire etc.).
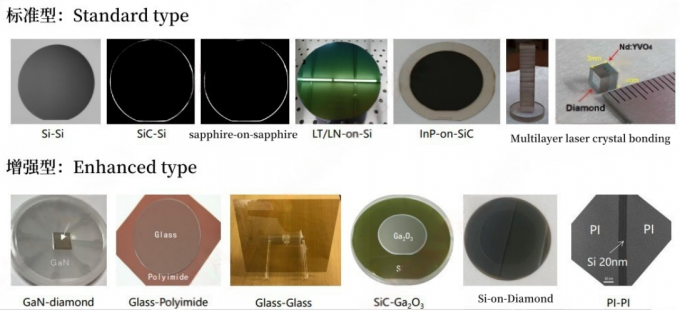
Systemet är utformat för både FoU-miljöer och massproduktion och integrerar ultraprecisionsinriktning, tryck- och temperaturreglering i sluten slinga och bindningsförhållanden i ultrahögt vakuum, vilket säkerställer hög bindningsstyrka, utmärkt gränssnittsuniformitet och låg defekttäthet.
Viktiga funktioner
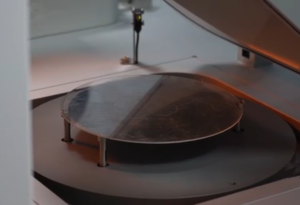 1. Avancerad limningsteknik i rumstemperatur
1. Avancerad limningsteknik i rumstemperatur
- Eliminerar termisk stress och waferförvrängning
- Möjliggör limning av temperaturkänsliga och olikartade material
- Stödjer hydrofil bindning och plasmaaktiverad bindning
2. Uppriktning med ultrahög precision
- Noggrannhet vid uppriktning av märke: ≤ ±2 μm
- Noggrannhet vid kantjustering: ≤ ±50 μm
- Valfri uppgradering till submikronuppriktningssystem
3. Hög bindningsstyrka och gränssnittskvalitet
- ≥ 2,0 J/m² (Si-Si direktlimning vid rumstemperatur)
- Upp till ≥5 J/m² med ytaktivering med plasma
- Utmärkt renhet i gränssnittet under UHV-förhållanden
4. Bred materialkompatibilitet
Stöder bindning av:
- Halvledare: Si, SiC, GaN, GaAs, InP
- Optiska material: Safir, glas
- Funktionella material: LiNbO₃, diamant
5. Flexibel processförmåga
- Wafer-storlek: 2″ - 12″
- Kompatibel med oregelbundet formade prover
- Valfria moduler: förvärmning/glödgning (RT-500°C)
Tekniska specifikationer
| Parameter | Specifikation |
|---|---|
| Metoder för limning | Direkt limning / Plasmaaktiverad limning |
| Wafer-storlek | 2″ - 12″ |
| Tryckområde | 0 - 10 MPa |
| Max kraft | 100 kN |
| Temperaturområde | Rumstemperatur - 500°C (tillval) |
| Vakuumnivå | ≤ 5 × 10-⁶ Torr |
| Noggrannhet i uppriktning | ≤ ±2 μm (märke), ≤ ±50 μm (kant) |
| Bindningsstyrka | ≥ 2,0 J/m² (RT Si-Si) |
 Intelligent styrsystem
Intelligent styrsystem
- HMI med pekskärm i industriell kvalitet
- Stödjer lagring av 50+ processrecept
- Sluten reglering av tryck och temperatur i realtid
- Stabila och repeterbara processprestanda
Säkerhet och tillförlitlighet
- Trippelt förreglingsskydd (tryck/temperatur/vakuum)
- Nödstoppssystem
- Utformad för renrumskompatibilitet i klass 100
Valfria konfigurationer
- Robotiserat system för hantering av wafers
- SECS/GEM-kommunikationsgränssnitt (förberett för fabriksintegration)
- Inline inspektionsmodul
- Enhet för aktivering av plasmaytor
Typiska tillämpningar
1. MEMS-förpackningar
Hermetisk tätning för sensorer som accelerometrar och gyroskop
2. 3D IC-integration
Wafer-stackning för TSV och avancerad paketering
3. Sammansatta halvledaranordningar
GaN / SiC bondning och lageröverföring för kraftaggregat
4. CMOS-bildsensorer (CIS)
Lågtemperatursbondning av CMOS-wafers och optiska substrat
5. Biochips och mikrofluidik
Tillförlitlig bondning för lab-on-chip-enheter
Exempel på process
LiNbO₃ - SiC Wafer Bonding (rumstemperatur)
- Uppnår ett starkt och enhetligt bindningsgränssnitt
- Verifierad genom TEM-avbildning i tvärsnitt
- Lämplig för högfrekventa och optoelektroniska applikationer
FRÅGOR OCH SVAR
F1: Varför välja waferbindning vid rumstemperatur istället för termisk bindning?
Bondning i rumstemperatur undviker termisk missanpassning och stress, vilket gör den idealisk för heterogena material och förbättrar utbytet i avancerade förpackningar.
F2: Vilka material kan limmas?
Systemet stöder ett brett utbud av material, inklusive:
- Halvledare: Si, SiC, GaN
- Oxider: SiO₂, LiNbO₃
- Metaller: Cu, Au
Varför välja detta system
- Beprövad prestanda vid tillverkning av SiC-kraftkomponenter
- Verifierad bindningsstyrka genom laboratorietester och TEM-analys
- Utformad för både forskningsinstitut och industriella produktionsanläggningar
- Modulär arkitektur ger långsiktig skalbarhet och uppgraderingsmöjligheter






Recensioner
Det finns inga recensioner än.