Wafer Bonding Equipment on suorituskykyinen järjestelmä, joka on suunniteltu kehittyneeseen puolijohteiden pakkaamiseen, MEMS-valmistukseen ja kolmannen sukupolven puolijohteiden integrointiin. Se tukee 2-12 tuuman kiekkoja ja mahdollistaa huoneenlämpötilassa tapahtuvan suoran liimauksen ja hydrofiilisen liimauksen, joten se soveltuu erityisen hyvin Si-Si, SiC-SiC ja heterogeenisten materiaalien liimaukseen (Si-SiC, GaN, safiiri jne.).
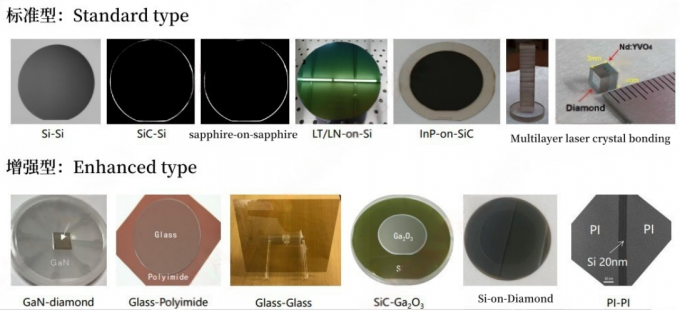
Järjestelmä on suunniteltu sekä tutkimus- ja kehitysympäristöihin että massatuotantoon, ja se sisältää erittäin tarkan kohdistuksen, suljetun silmukan paineen ja lämpötilan säädön sekä erittäin korkean tyhjiön liimausolosuhteet, mikä takaa korkean liimauslujuuden, erinomaisen rajapinnan tasaisuuden ja alhaisen vikatiheyden.
Tärkeimmät ominaisuudet
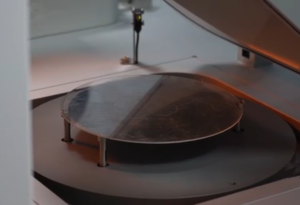 1. Kehittynyt huoneenlämpötilan liimaustekniikka
1. Kehittynyt huoneenlämpötilan liimaustekniikka
- Poistaa lämpöjännityksen ja kiekon vääntymisen.
- Mahdollistaa lämpötilaherkkien ja erilaisten materiaalien liimaamisen.
- Tukee hydrofiilistä ja plasma-aktivoitua liimausta.
2. Erittäin tarkka kohdistus
- Merkin kohdistustarkkuus: ≤ ±2 μm
- Reunan kohdistustarkkuus: ≤ ±50 μm
- Valinnainen päivitys submikroniseen kohdistusjärjestelmään
3. Korkea sidoslujuus ja rajapinnan laatu
- ≥ 2,0 J/m² (Si-Si-suoraliitos huoneenlämmössä)
- Jopa ≥5 J/m² plasmapinta-aktivoinnilla.
- Erinomainen rajapinnan puhtaus UHV-olosuhteissa
4. Laaja materiaalien yhteensopivuus
Tukee seuraavien liimausta:
- Puolijohteet: Puolijohteet: Si, SiC, GaN, GaAs, InP.
- Optiset materiaalit: Lasi
- Toiminnalliset materiaalit: Materiaalit: LiNbO₃, timantti
5. Joustava prosessikapasiteetti
- Kiekkojen koko: 2″ - 12″
- Yhteensopiva epäsäännöllisen muotoisten näytteiden kanssa
- Valinnaiset moduulit: esilämmitys / hehkutus (RT-500 °C).
Tekniset tiedot
| Parametri | Tekniset tiedot |
|---|---|
| Liimausmenetelmät | Suora liimaus / plasma-aktivoitu liimaus |
| Kiekon koko | 2″ - 12″ |
| Painealue | 0 - 10 MPa |
| Maksimivoima | 100 kN |
| Lämpötila-alue | Huonelämpötila - 500°C (valinnainen) |
| Tyhjiötaso | ≤ 5 × 10-⁶ Torr |
| Kohdistustarkkuus | ≤ ±2 μm (merkki), ≤ ±50 μm (reuna) |
| Liimauslujuus | ≥ 2,0 J/m² (RT Si-Si) |
 Älykäs ohjausjärjestelmä
Älykäs ohjausjärjestelmä
- Teollisen luokan kosketusnäytöllinen HMI
- Tukee yli 50 prosessireseptin tallennusta
- Reaaliaikainen paine- ja lämpötilansäätö suljetussa säätöpiirissä
- Vakaa ja toistettava prosessin suorituskyky
Turvallisuus ja luotettavuus
- Kolminkertainen lukitussuojaus (paine/lämpötila/tyhjiö)
- Hätäpysäytysjärjestelmä
- Suunniteltu yhteensopivaksi luokan 100 puhdastilojen kanssa
Valinnaiset kokoonpanot
- Robottikiekkojen käsittelyjärjestelmä
- SECS/GEM-viestintäliitäntä (valmius integrointiin)
- Inline-tarkastusmoduuli
- Plasmapinnan aktivointiyksikkö
Tyypilliset sovellukset
1. MEMS-pakkaukset
Kiihtyvyysantureiden ja gyroskooppien kaltaisten antureiden tiivistys ilmanpitävästi suljettuna
2. 3D IC-integraatio
Kiekkojen pinoaminen TSV:tä ja kehittyneitä pakkauksia varten
3. Yhdistetyt puolijohdekomponentit
GaN / SiC teholaitteiden liimaus ja kerrosten siirto
4. CMOS-kuva-anturit (CIS)
CMOS-kiekkojen ja optisten substraattien liimaaminen matalassa lämpötilassa
5. Biosirut ja mikrofluidiikka
Luotettava liimaus lab-on-chip-laitteille
Prosessi Esimerkki
LiNbO₃ - SiC-kiekon liimaus (huoneenlämpötila)
- Saavuttaa vahvan ja yhtenäisen liimausrajapinnan
- Varmistettu TEM-kuvauksella poikkileikkauksessa
- Soveltuu suurtaajuus- ja optoelektronisiin sovelluksiin.
KYSYMYKSET JA VASTAUKSET
Q1: Miksi valita huoneenlämpötilassa tapahtuva kiekkojen liimaus lämpöliimauksen sijaan?
Huoneenlämpötilassa tapahtuvalla liimauksella vältetään terminen epäsuhta ja jännitys, joten se sopii erinomaisesti heterogeenisille materiaaleille ja parantaa tuottoa kehittyneissä pakkauksissa.
Q2: Mitä materiaaleja voidaan liimata?
Järjestelmä tukee monenlaisia materiaaleja, kuten:
- Puolijohteet: Si, SiC, GaN
- Oksidit: LiNbO₃.
- Metallit: Cu, Au
Miksi valita tämä järjestelmä
- Todistettu suorituskyky SiC-teholaitteiden valmistuksessa
- Tarkistettu liimauslujuus laboratoriotestien ja TEM-analyysin avulla.
- Suunniteltu sekä tutkimuslaitoksille että teollisille tehtaille.
- Modulaarinen arkkitehtuuri takaa pitkän aikavälin skaalautuvuuden ja päivitettävyyden.






Arviot
Tuotearvioita ei vielä ole.