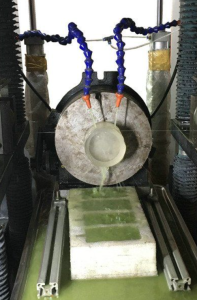 The diamond single/multi-wire dual-station wire saw machine is high-end precision equipment designed for processing hard and brittle materials. It uses electroplated diamond wire technology and features dual independent workstations, allowing flexible switching between single-wire precision mode and multi-wire batch production mode.
The diamond single/multi-wire dual-station wire saw machine is high-end precision equipment designed for processing hard and brittle materials. It uses electroplated diamond wire technology and features dual independent workstations, allowing flexible switching between single-wire precision mode and multi-wire batch production mode.
Equipped with high-precision motion control, intelligent tension systems, and adaptive cooling technology, it is ideal for precision cutting of semiconductor wafers, photovoltaic silicon wafers, and optical components.
Technical Specifications
| Parameter | Specification |
|---|---|
| Project | Single/multiple wire saw |
| Maximum Workpiece Size | ø320×430mm |
| Main Roller Coating Diameter | ø210×450mm (5 main rollers) |
| Wire Running Speed | 1000 (MIX) m/min |
| Diamond Wire Diameter | 0.2–0.37mm |
| Line Storage Capacity | 20 km (0.25mm wire diameter) |
| Cutting Thickness Range | 1.5–80mm |
| Cutting Accuracy | ±0.01mm |
| Vertical Lifting Stroke of Workstation | 350mm |
| Cutting Method | Workbench swings upwards, diamond wire remains stationary |
| Cutting Feed Speed | 0.01–10mm/min |
| Workstation | 2 |
| Water Tank | 300L |
| Cutting Fluid | Anti-rust high-efficiency cutting fluid |
| Swing Angle | ±8° |
| Swing Speed | 0.83°/s |
| Maximum Cutting Tension | 100N (min unit 0.1N) |
| Cutting Depth | 430mm |
| Power Supply | Three-phase five-wire AC380V/50Hz |
| Total Power | ≤52kW |
| Main Motor | 7.5×3kW |
| Wiring Motor | 0.75×2kW |
| Workbench Swing Motor | 1.3×2kW |
| Tension Control Motor | 4.4×2kW |
| Wire Release & Collection Motor | 5.5×2kW |
| External Dimensions | 2310×2660×2893mm |
| Machine Weight | 6000kg |
 Working Principle
Working Principle
-
Cutting System
-
Diamond wire forms a closed-loop motion driven by servo motors (adjustable 0.5–3 m/s)
-
Wire tension monitored in real-time via high-precision sensors (20–50N)
-
Worktable with linear motor drive ensures positioning accuracy of ±1 μm
-
-
Dual-Station Coordination
-
Station A: Single-wire mode (min diameter 0.1mm) for high-precision processing
-
Station B: Multi-wire mode (up to 200 wires) for mass production
-
Both stations can operate synchronously with automated workpiece transfer via robotic arm
-
-
Control System
-
PLC + PC architecture supporting G-code programming
-
Machine vision positioning system with 5 μm repeatability
-
Real-time monitoring of 20+ process parameters including cutting force and temperature
-
Core Features
-
High-Precision Processing
-
Sub-micron accuracy with air-bearing spindle and linear motor drive
-
Adaptive tension control for stable cutting
-
Advanced cooling system to control processing temperature
-
-
Flexible Production Modes
-
Single-station high-precision mode for R&D and small-batch needs
-
Multi-station parallel processing for high efficiency
-
Quick-change functionality for diverse production requirements
-
-
Intelligent Control System
-
Advanced HMI for user-friendly operation
-
Real-time monitoring and automatic optimization of key parameters
-
Remote diagnostics and maintenance capabilities
-
-
Robust & Durable Design
-
High-strength, wear-resistant materials for critical components
-
Modular structure facilitates maintenance
-
Comprehensive protection systems extend equipment lifespan
-
Applications
-
Semiconductor Wafer Manufacturing
-
SiC/GaN power device wafer cutting for EVs and 5G
-
Sapphire substrates for LEDs and consumer electronics
-
MEMS sensor chip dicing
-
-
Photovoltaic Production
-
Large monocrystalline silicon wafer slicing
-
Heterojunction solar cell processing
-
Ultra-thin silicon wafer cutting (<120 μm)
-
-
Optical Component Processing
-
Quartz glass optical elements
-
Laser crystals (YAG, sapphire)
-
Infrared optical windows
-
-
Special Material Processing
-
AlN / Al₂O₃ ceramic substrates
-
Silicon carbide composites
-
Ultra-hard materials (CVD diamond)
-
-
Research & Special Applications
-
Prototyping novel semiconductor materials
-
Micro-device development
-
Custom-shaped sample preparation
-
Technical Advantages
-
Stable processing quality with >99.5% yield
-
Adaptable to various hard/brittle materials
-
Significantly higher productivity than conventional methods
-
Easy operation and low total cost of ownership (TCO)
-
Custom solutions available, including cleanroom versions and special dimensions
FAQ
Q: What is the main advantage of a dual-station diamond wire saw?
A: Enables simultaneous single-wire precision cutting and multi-wire batch processing, boosting productivity by 50% compared to single-mode machines.
Q: Which materials can be cut with diamond wire dual-station saws?
A: Hard and brittle materials such as silicon, SiC, GaN, sapphire, quartz, and ceramics, with precision up to ±0.01mm.



Reviews
There are no reviews yet.