![]() Microfluidic laser equipment utilizes advanced microjet laser technology to provide high-precision, low-thermal-damage processing for semiconductor wafers and other hard, brittle, or wide bandgap materials. By combining a sub-micron water jet with a laser beam, the system guides the laser energy precisely to the workpiece surface, while the water stream continuously cools and removes debris. This technology effectively addresses the common challenges of conventional laser and mechanical processing, including thermal damage, microcracks, contamination, taper, and deformation.
Microfluidic laser equipment utilizes advanced microjet laser technology to provide high-precision, low-thermal-damage processing for semiconductor wafers and other hard, brittle, or wide bandgap materials. By combining a sub-micron water jet with a laser beam, the system guides the laser energy precisely to the workpiece surface, while the water stream continuously cools and removes debris. This technology effectively addresses the common challenges of conventional laser and mechanical processing, including thermal damage, microcracks, contamination, taper, and deformation.
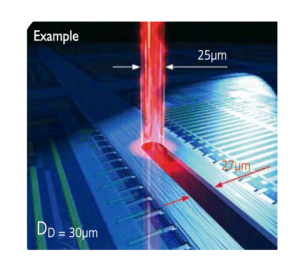 Các tính năng chính
Các tính năng chính
- Laser Type: Diode-pumped solid-state Nd:YAG laser, wavelength 532/1064 nm, pulse width in μs/ns, average power 10–200 W
- Water Jet System: Low-pressure, deionized, filtered water; ultrafine microjet consumes only 1 L/h at 300 bar, negligible force (<0.1 N)
- Nozzle: Sapphire or diamond, 30–150 μm diameter for precise laser guidance
- Auxiliary System: High-pressure pumps and water treatment units ensure stable jet performance
- Precision: Positioning accuracy ±5 μm, repeated positioning accuracy ±2 μm
- Processing Capability: Surface roughness Ra ≤1.2–1.6 μm, linear cutting speed ≥50 mm/s, opening speed ≥1.25 mm/s, circumference cutting ≥6 mm/s
Thông số kỹ thuật
| Thông số kỹ thuật | Option 1 | Option 2 |
|---|---|---|
| Countertop Volume (mm) | 300×300×150 | 400×400×200 |
| Linear Axis XY | Linear motor | Linear motor |
| Linear Axis Z | 150 | 200 |
| Positioning Accuracy (μm) | ±5 | ±5 |
| Repeated Positioning Accuracy (μm) | ±2 | ±2 |
| Acceleration (G) | 1 | 0.29 |
| Numerical Control | 3 axis / 3+1 / 3+2 axis | 3 axis / 3+1 / 3+2 axis |
| Wavelength (nm) | 532/1064 | 532/1064 |
| Rated Power (W) | 50/100/200 | 50/100/200 |
| Water Jet Pressure (bar) | 50–100 | 50–600 |
| Nozzle Size (μm) | 30–150 | 30–150 |
| Machine Dimensions (mm) | 1445×1944×2260 | 1700×1500×2120 |
| Weight (T) | 2.5 | 3 |
Ứng dụng
- Wafer Dicing & Cutting
- Materials: Silicon (Si), silicon carbide (SiC), gallium nitride (GaN) and other hard/brittle wafers
- Advantages: Replaces traditional diamond blades, reduces edge breakage (<5 μm vs. >20 μm), increases cutting speed by 30%, enables stealth dicing for ultra-thin wafers (<50 μm)
- Chip Drilling & Microhole Processing
- Applications: Through-silicon via (TSV) drilling, thermal microhole arrays for power devices
- Features: Aperture 10–200 μm, depth-to-width ratio up to 10:1, surface roughness Ra <0.5 μm
- Advanced Packaging
- Applications: RDL window opening, wafer-level packaging (Fan-Out WLP)
- Benefits: Avoids mechanical stress, improves yield to >99.5%
- Compound Semiconductor Processing
- Materials: GaN, SiC and other wide bandgap semiconductors
- Features: Gate notch etching, laser annealing, precise energy control to prevent thermal decomposition
- Defect Repair & Fine Tuning
- Applications: Laser fusing for memory circuits, microlens array tuning for optical sensors
- Accuracy: Energy control ±1%, repair positioning error <0.1 μm
![]()
Highlights & Advantages
- Cold, clean, and controlled processing minimizes heat damage, microcracks, and taper
- Ultra-fine water jet ensures precise laser guidance and efficient debris removal
- Suitable for hard, brittle, and transparent materials such as SiC, GaN, diamond, LTCC, and photovoltaic crystals
- Compatible with high-precision semiconductor fabrication, advanced packaging, aerospace components, and microelectronics
- Enhances yield, reduces material waste, and preserves material properties
Certification & Compliance
- RoHS compliant
- Designed for high-precision semiconductor applications
- Supports reproducible, repeatable, and automated processing
Câu hỏi thường gặp
1. What types of materials can be processed with microfluidic laser equipment?
Microfluidic laser technology can precisely process hard, brittle, and wide bandgap semiconductor materials, including silicon (Si), silicon carbide (SiC), gallium nitride (GaN), diamond, LTCC carbon ceramic substrates, photovoltaic crystals, and other advanced materials. It is ideal for applications requiring minimal thermal damage and high surface quality.
2. How does microjet laser technology improve semiconductor wafer manufacturing?
By combining a sub-micron water jet with a laser beam, the technology achieves sub-micron accuracy while minimizing heat-affected zones, contamination, and edge breakage. It replaces traditional mechanical blades for dicing, drilling, and microstructuring, improving yield and reducing material waste.
3. What applications is microfluidic laser equipment best suited for?
This equipment is widely used in:
- Wafer dicing and stealth dicing of ultra-thin wafers (<50 μm)
- Through-silicon via (TSV) drilling and microhole arrays for 3D ICs and power devices
- Advanced packaging, such as RDL window opening, wafer-level packaging (Fan-Out WLP), and gate etching/laser annealing for GaN and SiC semiconductors




Đánh giá
Chưa có đánh giá nào.