A 6/8/12 hüvelykes LPCVD-oxidációs kemence a legkorszerűbb félvezetőgyártó eszköz, amelyet precíz és egyenletes vékonyréteg-leválasztásra terveztek. Széles körben alkalmazzák a kiváló minőségű poliszilícium, szilícium-nitrid és szilícium-oxid rétegek ostyákon történő növesztésére, biztosítva az egyenletes teljesítményt a teljesítmény félvezetők, fejlett szubsztrátok és más nagy pontosságú alkalmazások esetében.
Ez a berendezés a fejlett alacsony nyomású leválasztási technológiát, az intelligens hőmérséklet-szabályozást és az ultra-tiszta folyamattervezést ötvözi a kivételes vékonyréteg-egyenletesség és a nagy áteresztőképesség elérése érdekében. Függőleges reaktorkonfigurációja lehetővé teszi a hatékony szakaszos feldolgozást, míg a termikus leválasztási folyamat elkerüli a plazma okozta károsodást, így ideális az olyan kritikus folyamatokhoz, mint a kapu dielektrikumának kialakítása, a feszültségpuffer rétegek és a védőoxidok.

Legfontosabb előnyök
- Nagy egyenletességű vékonyréteg-leválasztás: Az alacsony nyomású környezet (0,1-10 Torr) ±1,5% egyenletességet biztosít a waferek között és a waferen belül, ami kritikus a nagy teljesítményű eszközgyártás szempontjából.
- Függőleges reaktorkialakítás: 150-200 ostyát kezel tételenként, javítva az ipari méretű félvezetőgyártás áteresztőképességét és termelési hatékonyságát.
- Termikus leválasztási eljárás (500-900°C): Kíméletes, plazmamentes leválasztást biztosít az érzékeny hordozók védelme és a magas filmminőség fenntartása érdekében.
- Intelligens hőmérséklet-szabályozás: Valós idejű felügyelet és beállítás ±1°C pontossággal a stabil, megismételhető eredmények érdekében.
- Ultratiszta technológiai kamra: Minimálisra csökkenti a részecskeszennyeződést, támogatja a SiC és más fejlett ostyaanyagokat.
- Testreszabható konfiguráció: A rugalmas kialakítás különböző technológiai követelményekhez igazodik, beleértve a száraz vagy nedves oxidációt és a különböző ostyaméreteket.
Műszaki specifikációk
| Jellemző | Specifikáció |
|---|---|
| Wafer méret | 6/8/12 hüvelyk |
| Kompatibilis anyagok | Poliszilícium, szilícium-nitrid, szilícium-oxid |
| Oxidációs típus | Száraz oxigén / nedves oxigén (DCE, HCL) |
| Folyamathőmérséklet-tartomány | 500°C-900°C |
| Állandó hőmérsékletű zóna | ≥800 mm |
| Hőmérséklet-szabályozás pontossága | ±1°C |
| Részecskék ellenőrzése | 0,32μm), 0,32μm), 0,226μm) |
| Filmvastagság | NIT1500 ±50 Å |
| Egyenletesség | Waferen belül <2.5%, waferről waferre <2.5%, tételről tételre <2% |
A termék jellemzői
- Az automatizált ostyakezelés nagyfokú biztonságot és működési hatékonyságot biztosít.
- Az ultra-tiszta technológiai kamra csökkenti a szennyeződés kockázatát és fenntartja a film egyenletes minőségét.
- A kiváló filmvastagság egyenletessége támogatja a fejlett csomópontgyártást.
- A valós idejű intelligens hőmérséklet- és nyomásszabályozás lehetővé teszi a folyamat pontos beállítását.
- A SiC ostyatartó csökkenti a súrlódást és a részecskeképződést, meghosszabbítva ezzel az ostya élettartamát.
- A moduláris felépítés lehetővé teszi a különböző alkalmazásokhoz és folyamatigényekhez való testreszabást.
A lerakási folyamat elve
- Gáz Bevezetés: A reakcióképes gázokat alacsony nyomáson (0,25-1 Torr) vezetik a csőbe.
- Felületi diffúzió: A molekulák szabadon diffundálnak az ostya felületén, így biztosítva az egyenletes lefedettséget.
- Adszorpció: A reakcióképes anyagok a kémiai reakció előtt megtapadnak az ostya felületén.
- Kémiai reakció: A termikus bomlás közvetlenül a hordozón alakítja ki a kívánt vékonyréteget.
- Melléktermék eltávolítása: A nem reaktív gázokat evakuálják a tisztaság fenntartása és az interferencia megelőzése érdekében.
- Filmalakítás: A reakciótermékek fokozatosan felhalmozódnak, egységes, stabil vékonyréteget képezve.
Alkalmazások
- Árnyékoló oxidréteg: Védi a szilíciumszeleteket a szennyeződéstől és csökkenti az ioncsatornázást az adalékolási folyamatok során.

- Pad oxid réteg: A szilícium és a szilícium-nitrid rétegek közötti feszültségpufferként működik, megakadályozza a szilíciumszelet repedését és javítja a hozamot.

- Kapu oxidréteg: A MOS-struktúrákban a dielektromos réteget biztosítja, amely precíz áramvezetést és mezőhatás-szabályozást biztosít.

Rendszerkonfigurációk
- Függőleges LPCVD: A folyamatgázok felülről lefelé áramlanak, így egyenletes lerakódás érhető el a tételben lévő összes ostyán.

- Vízszintes LPCVD: A gázok a szubsztrátumok hosszában áramlanak, ami folyamatos, nagy volumenű gyártásra alkalmas, bár a lerakódás vastagsága a bemeneti oldal közelében kissé változhat.

Gyakran ismételt kérdések
1. kérdés: Mire használják elsősorban az LPCVD-t?
V: Az LPCVD egy alacsony nyomású vékonyréteg-leválasztási eljárás, amelyet széles körben alkalmaznak a félvezetőgyártásban poliszilícium, szilícium-nitrid és szilícium-oxid leválasztására, lehetővé téve a fejlett eszközgyártáshoz szükséges egyenletes és kiváló minőségű filmek előállítását.
2. kérdés: Miben különbözik az LPCVD a PECVD-től?
V: Az LPCVD alacsony nyomáson történő termikus aktiválásra támaszkodik a nagy tisztaságú filmek előállítása érdekében, míg a PECVD alacsonyabb hőmérsékleten plazmát használ a gyorsabb leválasztás érdekében, gyakran kissé alacsonyabb filmminőség mellett.
3. kérdés: Milyen ostyaméretek és anyagok kompatibilisek ezzel az LPCVD oxidációs kemencével?
V: Ez a kemence támogatja a 6 hüvelykes, 8 hüvelykes és 12 hüvelykes ostyákat, és kompatibilis a poliszilícium, szilícium-nitrid, szilícium-oxid és SiC ostyákkal, így rugalmasan alkalmazható a különböző félvezető alkalmazásokhoz.
4. kérdés: Az LPCVD oxidációs kemence testre szabható speciális folyamatokhoz?
V: Igen, a rendszer moduláris konfigurációkat kínál, beleértve az állítható hőmérsékleti zónákat, a gázáramlás-szabályozást és az oxidációs üzemmódokat (száraz vagy nedves), lehetővé téve, hogy megfeleljen a kutatási és az ipari méretű gyártás különböző technológiai követelményeinek.







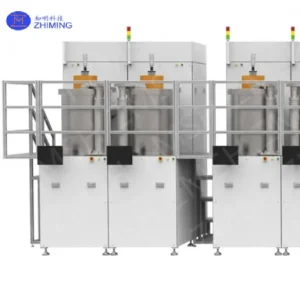
Értékelések
Még nincsenek értékelések.