 HP-1201 自動切割機是專為大尺寸基板和多工件切割應用而設計的高性能解決方案。該系統專為滿足先進半導體封裝和基板加工不斷發展的需求而設計,同時支援晶圓切割(最大 12 英寸)和最大 400 × 400 mm 的大面積工件。.
HP-1201 自動切割機是專為大尺寸基板和多工件切割應用而設計的高性能解決方案。該系統專為滿足先進半導體封裝和基板加工不斷發展的需求而設計,同時支援晶圓切割(最大 12 英寸)和最大 400 × 400 mm 的大面積工件。.
HP-1201 具有堅固的龍門結構、對向雙主軸配置以及可客製化的工作平台,可提供卓越的剛性、穩定性和產量。它特別適用於涉及帶狀材料、多模具面板和複雜工件佈局的應用。.
該機器整合了高精度校準、智慧檢測和彈性加工功能,是追求生產力和切割精度的製造商的理想選擇。.
主要功能
1.專為大尺寸基板設計
與傳統切割系統不同,HP-1201 已針對大型工件和包裝基板進行最佳化:
- 支援最大 400 mm × 400 mm 的方形材料
- 與 12 吋及以下晶圓相容
- 面板級和先進封裝製程的理想選擇
這使得它能夠高度適應半導體和新興封裝技術。.
2.高效率的多片切割能力
該系統在多條帶和批量處理應用中表現出色:
- 支援同時放置多個工件
- 範例:一個循環最多可處理 5 條帶材 (250 mm × 70 mm)
- 大幅提升產能並縮短處理時間
這項功能對於高產量的生產環境特別有價值。.
3.對置雙主軸系統提高生產力
HP-1201 採用雙主軸結構,主軸間距≤ 22 mm:
- 可進行平行或順序切割作業
- 縮短空轉行程距離
- 提高切割效率和整體產量
結合高速主軸旋轉(高達 60,000 rpm),系統可確保快速、精確的材料分離。.
4.龍門結構提供優異的穩定性
本機採用高剛性龍門設計:
- 增強高速運轉時的結構穩定性
- 減少振動,提高切割精度
- 適用於脆性材料的精密切割
即使在嚴苛的加工條件下,也能確保穩定的效能。.
5.先進的校準和檢測系統
配備雙顯微鏡配置:
- 實現快速、精確的自動對位
- 支援高解析度切口檢測
- 改善切割一致性並減少瑕疵
這對於在半導體製造過程中保持嚴格的公差至關重要。.
6.選購的 Sub-CT 刀片修整功能
選購的 Sub-CT 輔助刀片修整功能有助於維持最佳的刀片狀態:
- 減少邊緣崩裂和表面缺陷
- 延長刀片使用壽命
- 改善整體切割品質
7.選購的深切割冷卻系統
可選配深切割冷卻水系統:
- 提高切割時的冷卻效率
- 減少材料的熱損傷
- 改善表面品質與切削精度
技術規格
| 參數 | 規格 |
|---|---|
| 主軸功率 | 1.8 千瓦 |
| 主軸轉速 | 6000 - 60000 rpm |
| X 軸行程 | 420 公釐 |
| X 軸速度 | 0.1 - 1000 mm/s |
| X 軸解析度 | 0.001 mm |
| Y1/Y2 旅遊 | 420 公釐 |
| Y 軸解析度 | 0.0001 mm |
| 定位精度 | 0.002 mm |
| 累積誤差 | 0.003 / 400 mm |
| Z1/Z2 旅遊 | 13 mm |
| 重複性 | 0.001 mm |
| Theta 旋轉 | 380° ± 5° |
| 角度精度 | 1 弧秒 |
| 顯微鏡放大倍率 | 1.5 倍 (選購) / 0.8 倍 |
| 照明 | 環形光源 + 同軸光源 |
| 最大工件 (圓形) | 直徑 300 公釐 |
| 最大工件 (方形) | 400 × 400 公釐 |
| 機器尺寸 (寬×深×高) | 1450 × 1250 × 1850 公釐 |
| 重量 | 2000 公斤 |
應用
HP-1201 廣泛應用於需要高精度切割大型或多工件的先進製造領域:
- 半導體晶圓切割 (≤ 12 inch)
- 先進封裝基板
- 面板層級封裝 (PLP)
- LED 與光電材料
- 陶瓷和硬脆材料
- 多條和批量切割應用
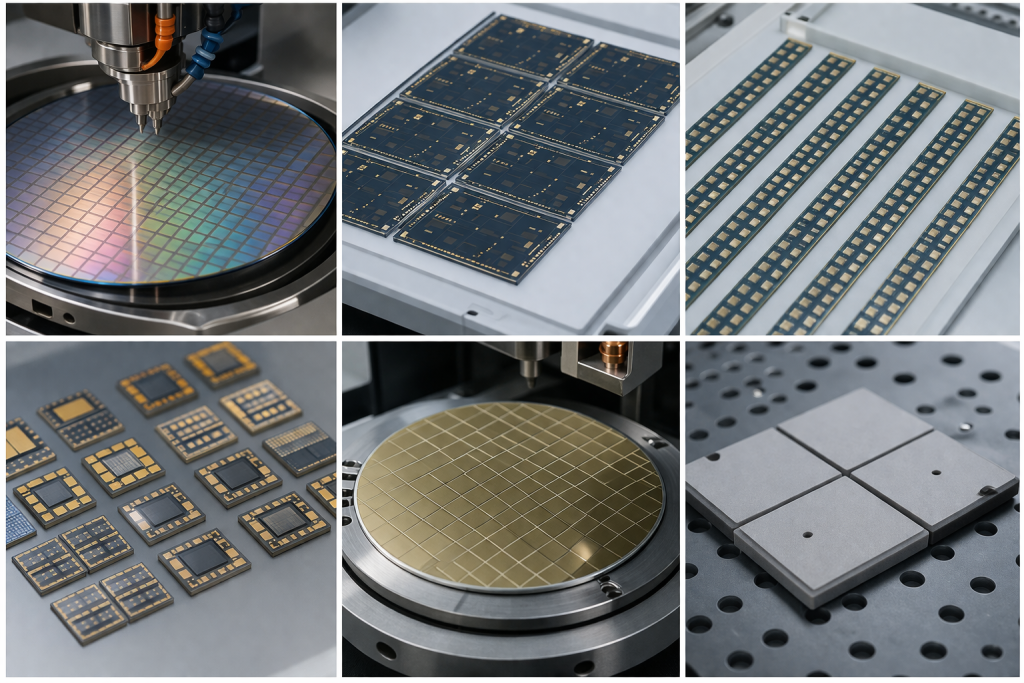
核心優勢
高產量
多工件加工和雙主軸設計大大提高了生產效率。.
彈性處理
可客製化的工作台允許處理各種形狀和佈局。.
精確度與穩定性
龍門結構和先進的校準系統確保了高精度和可重複性。.
成本效益
縮短製程時間並提高刀片壽命,降低整體營運成本。.
常見問題 (FAQ)
1.HP-1201 支援的最大工件尺寸是多少?
HP-1201 同時支援晶圓和大幅面基板。它可以處理最大 12 英吋 (Ø300 mm) 的圓形晶圓和最大 400 × 400 mm 的方形工件。這使得它特別適用於先進的封裝和面板級應用。.
2.HP-1201 是否適合多件或帶狀切割應用?
HP-1201 特別針對多件和帶材切割進行了最佳化。它可以在單個週期內加工多條帶材 - 例如,最多可加工 5 片 250 mm × 70 mm 的帶材 - 大幅提高產量,並縮短批量生產的處理時間。.
3.機器如何確保切割精度和穩定性?
HP-1201 透過下列組合確保高精度:
- 高剛性的龍門結構,使操作更穩定
- 雙顯微鏡系統可進行精確的校準和檢測
- 高解析度運動控制(解析度高達 0.0001 mm)
- 雙主軸配置可達到平衡且高效的切削效果
這些特點共同作用,在要求嚴苛的應用中提供一致的切割品質、最小的崩角和可靠的性能。.





商品評價
目前沒有評價。