6/8/12-Inch LPCVD 氧化爐是最先進的半導體製造工具,專為精確、均勻的薄膜沉積而設計。它廣泛應用於在晶圓上生長高品質的多晶矽、氮化矽和氧化矽層,確保功率半導體、先進基板和其他高精密應用的穩定效能。.
此設備結合了先進的低壓沉積技術、智慧型溫度控制及超潔淨製程設計,可達到卓越的薄膜均勻性及高產量。其垂直反應器配置可實現高效率的批次處理,而其熱沉積製程則可避免等離子造成的損害,使其成為閘極電介質形成、應力緩衝層和保護性氧化物等關鍵製程的理想選擇。.

主要優勢
- 高均勻性薄膜沉積: 低壓環境(0.1-10 Torr)可確保晶圓與晶圓之間及晶圓內的均勻性達到 ±1.5%,這對於高效能元件製造來說至關重要。.
- 垂直反應器設計: 每批可處理 150-200 片晶圓,提高了工業規模半導體製造的產量和生產效率。.
- 熱沉積製程 (500-900°C): 提供溫和、無電漿沉積,可保護敏感基板並維持高薄膜品質。.
- 智慧型溫度控制: 即時監控與調整,精確度達 ±1°C,提供穩定、可重複的結果。.
- 超潔淨的製程室: 最小化微粒污染,支援 SiC 及其他先進晶圓材料。.
- 可自訂組態: 靈活的設計可滿足各種製程需求,包括乾式或濕式氧化以及不同的晶圓尺寸。.
技術規格
| 特點 | 規格 |
|---|---|
| 晶圓尺寸 | 6/8/12 英吋 |
| 相容材料 | 多晶矽、氮化矽、氧化矽 |
| 氧化類型 | 乾氧 / 濕氧 (DCE、HCL) |
| 製程溫度範圍 | 500°C-900°C |
| 恆溫區 | ≥800 mm |
| 溫度控制精度 | ±1°C |
| 微粒控制 | 0.32μm), 0.32μm), 0.226μm) |
| 薄膜厚度 | NIT1500 ±50 Å |
| 均一性 | 晶圓內 <2.5%、晶圓間 <2.5%、批次間 <2% |
產品特色
- 自動化晶圓處理確保高安全性和運作效率。.
- 超潔淨的製程室可降低污染風險,並維持一致的薄膜品質。.
- 優異的薄膜厚度均勻性可支援先進的節點製造。.
- 即時智慧型溫度與壓力控制可精確調整製程。.
- SiC 晶圓支架可減少摩擦和微粒的產生,延長晶圓的使用壽命。.
- 模組化設計可針對不同的應用和製程需求進行客製化。.
沉積製程原理
- 瓦斯簡介: 反應氣體在低壓條件下(0.25-1 Torr)導入管內。.
- 表面擴散: 分子可在晶圓表面自由擴散,確保覆蓋範圍均勻。.
- 吸附: 反應物在化學反應前會附著在晶圓表面。.
- 化學反應: 熱分解可直接在基板上形成所需的薄膜。.
- 副產品清除: 非反應性氣體會被排空,以保持純度和防止干擾。.
- 電影形成: 反應生成物逐漸累積,形成均勻、穩定的薄膜層。.
應用
- 屏蔽氧化層: 保護矽晶圓免受污染,並在摻雜製程中減少離子通道。.

- 墊氧化層: 可作為矽層與氮化矽層之間的應力緩衝區,防止晶圓開裂並提昇良率。.

- 閘極氧化層: 在 MOS 結構中提供介質層,確保精確的電流傳導和場效控制。.

系統組態
- 垂直 LPCVD: 製程氣體自上而下流動,可在批次中的所有晶圓上實現均勻沉積。.

- 水平 LPCVD: 氣體沿著基板的長度流動,適用於連續、大量的生產,但沉積厚度在靠近進氣口一側可能會略有變化。.

常見問題
Q1: LPCVD 主要用於何種用途?
答:LPCVD 是一種低壓薄膜沉積製程,廣泛用於半導體製造中的多晶矽、氮化矽和氧化矽的沉積,可製造出均勻且高品質的薄膜,用於先進的裝置製造。.
Q2: LPCVD 與 PECVD 有何不同?
答:LPCVD 依賴低壓下的熱活化來製造高純度薄膜,而 PECVD 則使用低溫下的電漿來加快沉積速度,但通常薄膜品質會略差。.
Q3: 此 LPCVD 氧化爐與哪些晶圓尺寸和材料相容?
答:本爐支援 6 吋、8 吋和 12 吋晶圓,並與多晶矽、氮化矽、氧化矽和 SiC 晶圓相容,為各種半導體應用提供彈性。.
Q4: LPCVD 氧化爐可以針對特定製程進行客製化嗎?
答:是的,該系統提供模組化配置,包括可調溫區、氣流控制和氧化模式(乾式或濕式),可滿足研究和工業規模生產的各種製程要求。.







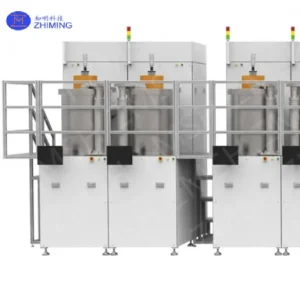
商品評價
目前沒有評價。