Il forno di ossidazione LPCVD da 6/8/12 pollici è uno strumento all'avanguardia per la produzione di semiconduttori, progettato per la deposizione precisa e uniforme di film sottili. È ampiamente utilizzato per la produzione di strati di polisilicio, nitruro di silicio e ossido di silicio di alta qualità su wafer, garantendo prestazioni costanti per semiconduttori di potenza, substrati avanzati e altre applicazioni di alta precisione.
Questa apparecchiatura combina una tecnologia avanzata di deposizione a bassa pressione, un controllo intelligente della temperatura e un design di processo ultra-pulito per ottenere un'eccezionale uniformità del film sottile e un'elevata produttività. La configurazione verticale del reattore consente un'efficiente lavorazione in batch, mentre il processo di deposizione termica evita i danni indotti dal plasma, rendendolo ideale per processi critici come la formazione del dielettrico del gate, gli strati di compensazione delle sollecitazioni e gli ossidi protettivi.

Vantaggi principali
- Deposizione di film sottili ad alta uniformità: L'ambiente a bassa pressione (0,1-10 Torr) garantisce un'uniformità da wafer a wafer e all'interno del wafer di ±1,5%, fondamentale per la fabbricazione di dispositivi ad alte prestazioni.
- Progettazione del reattore verticale: Gestisce 150-200 wafer per lotto, migliorando la produttività e l'efficienza produttiva per la produzione di semiconduttori su scala industriale.
- Processo di deposizione termica (500-900°C): Offre una deposizione delicata e priva di plasma per proteggere i substrati sensibili e mantenere un'elevata qualità del film.
- Controllo intelligente della temperatura: Monitoraggio e regolazione in tempo reale con precisione di ±1°C per risultati stabili e ripetibili.
- Camera di processo ultra-pulita: Riduce al minimo la contaminazione da particelle, supportando SiC e altri materiali avanzati per wafer.
- Configurazione personalizzabile: Il design flessibile si adatta a vari requisiti di processo, tra cui l'ossidazione a secco o a umido e le diverse dimensioni dei wafer.
Specifiche tecniche
| Caratteristica | Specifiche |
|---|---|
| Dimensione del wafer | 6/8/12 Pollici |
| Materiali compatibili | Polisilicio, nitruro di silicio, ossido di silicio |
| Tipo di ossidazione | Ossigeno secco / Ossigeno umido (DCE, HCL) |
| Intervallo di temperatura di processo | 500°C-900°C |
| Zona a temperatura costante | ≥800 mm |
| Precisione del controllo della temperatura | ±1°C |
| Controllo delle particelle | 0,32μm), 0,32μm), 0,226μm) |
| Spessore del film | NIT1500 ±50 Å |
| Uniformità | All'interno del wafer <2,5%, da wafer a wafer <2,5%, da lotto a lotto <2% |
Caratteristiche del prodotto
- La manipolazione automatizzata dei wafer garantisce un'elevata sicurezza ed efficienza operativa.
- La camera di processo ultra-pulita riduce il rischio di contaminazione e mantiene costante la qualità del film.
- L'uniformità superiore dello spessore del film supporta la produzione di nodi avanzati.
- Il controllo intelligente della temperatura e della pressione in tempo reale consente regolazioni precise del processo.
- Il supporto per wafer in SiC riduce l'attrito e la generazione di particelle, prolungando la durata del wafer.
- Il design modulare consente la personalizzazione per diverse applicazioni ed esigenze di processo.
Principio del processo di deposizione
- Introduzione al gas: I gas reagenti vengono introdotti nel tubo in condizioni di bassa pressione (0,25-1 Torr).
- Diffusione superficiale: Le molecole si diffondono liberamente sulla superficie del wafer, garantendo una copertura uniforme.
- Assorbimento: I reagenti aderiscono alla superficie del wafer prima della reazione chimica.
- Reazione chimica: La decomposizione termica forma il film sottile desiderato direttamente sul substrato.
- Rimozione dei sottoprodotti: I gas non reattivi vengono evacuati per mantenere la purezza e prevenire le interferenze.
- Formazione del film: I prodotti di reazione si accumulano gradualmente, formando uno strato di pellicola sottile uniforme e stabile.
Applicazioni
- Strato di ossido schermante: Protegge i wafer di silicio dalla contaminazione e riduce la canalizzazione degli ioni durante i processi di drogaggio.

- Strato di ossido di tampone: Agisce come cuscinetto di tensione tra gli strati di silicio e nitruro di silicio, impedendo la fessurazione del wafer e migliorando la resa.

- Strato di ossido di gate: Fornisce lo strato dielettrico nelle strutture MOS, assicurando una precisa conduzione della corrente e un controllo degli effetti di campo.

Configurazioni del sistema
- LPCVD verticale: I gas di processo fluiscono dall'alto verso il basso, ottenendo una deposizione uniforme su tutti i wafer di un lotto.

- LPCVD orizzontale: I gas fluiscono lungo la lunghezza dei substrati, adatti per una produzione continua e ad alto volume, anche se lo spessore di deposizione può variare leggermente vicino al lato di ingresso.

Domande frequenti
D1: Per cosa viene utilizzato principalmente l'LPCVD?
R: LPCVD è un processo di deposizione di film sottili a bassa pressione ampiamente utilizzato nella produzione di semiconduttori per la deposizione di polisilicio, nitruro di silicio e ossido di silicio, che consente di ottenere film uniformi e di alta qualità per la fabbricazione di dispositivi avanzati.
D2: In che modo LPCVD si differenzia da PECVD?
R: L'LPCVD si basa sull'attivazione termica a bassa pressione per produrre film di elevata purezza, mentre il PECVD utilizza il plasma a temperature più basse per una deposizione più rapida, spesso con una qualità del film leggermente inferiore.
D3: Quali dimensioni e materiali dei wafer sono compatibili con questo forno di ossidazione LPCVD?
R: Questo forno supporta wafer da 6, 8 e 12 pollici ed è compatibile con wafer di polisilicio, nitruro di silicio, ossido di silicio e SiC, offrendo flessibilità per varie applicazioni di semiconduttori.
D4: Il forno di ossidazione LPCVD può essere personalizzato per processi specifici?
R: Sì, il sistema offre configurazioni modulari, tra cui zone a temperatura regolabile, controllo del flusso di gas e modalità di ossidazione (a secco o a umido), che consentono di soddisfare diversi requisiti di processo sia per la ricerca che per la produzione su scala industriale.







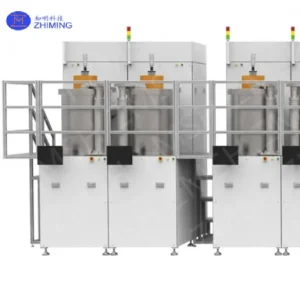
Recensioni
Ancora non ci sono recensioni.