เตาออกซิเดชัน LPCVD ขนาด 6/8/12 นิ้ว เป็นเครื่องมือการผลิตเซมิคอนดักเตอร์ที่ทันสมัย ออกแบบมาเพื่อการเคลือบฟิล์มบางอย่างแม่นยำและสม่ำเสมอ ใช้กันอย่างแพร่หลายในการปลูกชั้นโพลีซิลิคอน ซิลิคอนไนไตรด์ และซิลิคอนออกไซด์คุณภาพสูงบนเวเฟอร์ เพื่อให้มั่นใจถึงประสิทธิภาพที่สม่ำเสมอสำหรับเซมิคอนดักเตอร์พลังงาน แผ่นฐานขั้นสูง และการใช้งานที่ต้องการความแม่นยำสูงอื่นๆ.
อุปกรณ์นี้ผสานเทคโนโลยีการเคลือบผิวด้วยแรงดันต่ำขั้นสูง การควบคุมอุณหภูมิอัจฉริยะ และการออกแบบกระบวนการที่สะอาดเป็นพิเศษ เพื่อให้ความสม่ำเสมอของฟิล์มบางเป็นเลิศและประสิทธิภาพการผลิตสูง การกำหนดค่าของตัวทำปฏิกิริยาแบบตั้งตรงช่วยให้สามารถประมวลผลแบบแบตช์ได้อย่างมีประสิทธิภาพ ในขณะที่กระบวนการเคลือบด้วยความร้อนหลีกเลี่ยงความเสียหายที่เกิดจากพลาสมา ทำให้เหมาะอย่างยิ่งสำหรับกระบวนการสำคัญ เช่น การสร้างไดอิเล็กทริกของเกต ชั้นบัฟเฟอร์ความเครียด และออกไซด์ป้องกัน.

ข้อได้เปรียบหลัก
- การเคลือบฟิล์มบางที่มีความสม่ำเสมอสูง สภาพแวดล้อมความดันต่ำ (0.1–10 Torr) รับประกันความสม่ำเสมอของแผ่นเวเฟอร์ต่อแผ่นเวเฟอร์และความสม่ำเสมอภายในแผ่นเวเฟอร์ที่ ±1.5% ซึ่งมีความสำคัญอย่างยิ่งสำหรับการผลิตอุปกรณ์ประสิทธิภาพสูง.
- การออกแบบเครื่องปฏิกรณ์แนวตั้ง: รองรับการจัดการเวเฟอร์ 150–200 ชิ้นต่อชุด ช่วยเพิ่มประสิทธิภาพการผลิตและปริมาณงานสำหรับการผลิตเซมิคอนดักเตอร์ในระดับอุตสาหกรรม.
- กระบวนการตกตะกอนด้วยความร้อน (500–900°C): ให้การเคลือบที่อ่อนโยน ปราศจากพลาสมา เพื่อปกป้องวัสดุที่บอบบางและรักษาคุณภาพของฟิล์มให้สูง.
- การควบคุมอุณหภูมิอัจฉริยะ: การตรวจสอบและปรับแบบเรียลไทม์ด้วยความแม่นยำ ±1°C เพื่อให้ได้ผลลัพธ์ที่เสถียรและสามารถทำซ้ำได้.
- ห้องกระบวนการสะอาดพิเศษ ลดการปนเปื้อนของอนุภาค รองรับวัสดุเวเฟอร์ขั้นสูง เช่น ซิลิคอนคาร์ไบด์ (SiC) และวัสดุอื่น ๆ.
- การกำหนดค่าแบบปรับแต่งได้: การออกแบบที่ยืดหยุ่นรองรับความต้องการของกระบวนการต่างๆ รวมถึงการออกซิเดชันแบบแห้งหรือเปียกและขนาดของเวเฟอร์ที่แตกต่างกัน.
ข้อมูลจำเพาะทางเทคนิค
| คุณสมบัติ | ข้อกำหนด |
|---|---|
| ขนาดเวเฟอร์ | 6/8/12 นิ้ว |
| วัสดุที่เข้ากันได้ | โพลีซิลิคอน, ซิลิคอนไนไตรด์, ซิลิคอนออกไซด์ |
| ประเภทออกซิเดชัน | ออกซิเจนแห้ง / ออกซิเจนเปียก (DCE, HCL) |
| ช่วงอุณหภูมิของกระบวนการ | 500°C–900°C |
| โซนอุณหภูมิคงที่ | ≥800 มม. |
| ความแม่นยำในการควบคุมอุณหภูมิ | ±1°C |
| การควบคุมอนุภาค | 0.32μm), 0.32μm), 0.226μm) |
| ความหนาของฟิล์ม | NIT1500 ±50 Å |
| ความสม่ำเสมอ | ภายในเวเฟอร์ <2.5%, เวเฟอร์ต่อเวเฟอร์ <2.5%, ชุดต่อชุด <2% |
คุณสมบัติของสินค้า
- การจัดการเวเฟอร์แบบอัตโนมัติช่วยให้มั่นใจในความปลอดภัยสูงและประสิทธิภาพในการดำเนินงาน.
- ห้องกระบวนการที่สะอาดเป็นพิเศษช่วยลดความเสี่ยงของการปนเปื้อนและรักษาคุณภาพของฟิล์มให้คงที่.
- ความสม่ำเสมอของความหนาของฟิล์มที่เหนือกว่าช่วยสนับสนุนการผลิตในโหนดขั้นสูง.
- การควบคุมอุณหภูมิและความดันแบบเรียลไทม์อัจฉริยะช่วยให้สามารถปรับกระบวนการได้อย่างแม่นยำ.
- แผ่นรองซิลิคอนคาร์ไบด์ช่วยลดแรงเสียดทานและการเกิดอนุภาค ซึ่งช่วยยืดอายุการใช้งานของแผ่นเวเฟอร์.
- การออกแบบแบบโมดูลาร์ช่วยให้สามารถปรับแต่งได้สำหรับการใช้งานที่หลากหลายและความต้องการของกระบวนการ.
หลักการของกระบวนการให้ถ้อยคำเป็นลายลักษณ์อักษร
- การแนะนำแก๊ส: ก๊าซตัวทำปฏิกิริยาถูกนำเข้าสู่ท่อภายใต้สภาวะความดันต่ำ (0.25–1 Torr).
- การแพร่กระจายบนผิวหน้า โมเลกุลแพร่กระจายอย่างอิสระข้ามผิวหน้าของเวเฟอร์ ทำให้เกิดการปกคลุมอย่างสม่ำเสมอ.
- การดูดซับ สารตั้งต้นยึดติดกับพื้นผิวของเวเฟอร์ก่อนเกิดปฏิกิริยาเคมี.
- ปฏิกิริยาเคมี: การสลายตัวทางความร้อนก่อให้เกิดฟิล์มบางที่ต้องการโดยตรงบนพื้นผิวรองรับ.
- การกำจัดผลพลอยได้ ก๊าซที่ไม่ทำปฏิกิริยาจะถูกดูดออกเพื่อรักษาความบริสุทธิ์และป้องกันการรบกวน.
- การก่อตัวของฟิล์ม: ผลิตภัณฑ์ปฏิกิริยาจะสะสมเพิ่มขึ้นอย่างค่อยเป็นค่อยไป จนก่อตัวเป็นชั้นฟิล์มบางที่มีความสม่ำเสมอและเสถียร.
การประยุกต์ใช้
- ชั้นออกไซด์ป้องกัน ปกป้องแผ่นเวเฟอร์ซิลิคอนจากการปนเปื้อนและลดการเกิดช่องไอออนในระหว่างกระบวนการโดป.

- ชั้นออกไซด์ของแผ่น ทำหน้าที่เป็นตัวกันกระแทกระหว่างชั้นซิลิคอนและชั้นซิลิคอนไนไตรด์ ช่วยป้องกันการแตกร้าวของเวเฟอร์และเพิ่มผลผลิต.

- ชั้นออกไซด์เกต: ให้ชั้นไดอิเล็กทริกในโครงสร้าง MOS, ทำให้การนำกระแสไฟฟ้าและการควบคุมสนามไฟฟ้าเป็นไปอย่างแม่นยำ.

การกำหนดค่าระบบ
- LPCVD แนวตั้ง: ก๊าซกระบวนการไหลจากบนลงล่าง ทำให้เกิดการสะสมอย่างสม่ำเสมอบนเวเฟอร์ทุกชิ้นในชุด.

- LPCVD แนวนอน: ก๊าซไหลไปตามความยาวของพื้นผิวรองรับ ซึ่งเหมาะสำหรับการผลิตอย่างต่อเนื่องในปริมาณมาก แม้ว่าความหนาของการสะสมอาจแตกต่างกันเล็กน้อยบริเวณใกล้ด้านทางเข้า.

คำถามที่พบบ่อย
คำถามที่ 1: LPCVD ใช้สำหรับอะไรเป็นหลัก?
A: LPCVD เป็นกระบวนการเคลือบฟิล์มบางแบบความดันต่ำที่ใช้กันอย่างแพร่หลายในการผลิตเซมิคอนดักเตอร์สำหรับการเคลือบโพลีซิลิคอน ซิลิคอนไนไตรด์ และซิลิคอนออกไซด์ ช่วยให้ได้ฟิล์มที่มีความสม่ำเสมอและคุณภาพสูงสำหรับการผลิตอุปกรณ์ขั้นสูง.
คำถามที่ 2: LPCVD แตกต่างจาก PECVD อย่างไร?
A: LPCVD อาศัยการกระตุ้นทางความร้อนภายใต้ความดันต่ำเพื่อผลิตฟิล์มที่มีความบริสุทธิ์สูง ในขณะที่ PECVD ใช้พลาสมาที่อุณหภูมิต่ำกว่าสำหรับการสะสมที่เร็วกว่า โดยมักจะมีคุณภาพฟิล์มที่ต่ำกว่าเล็กน้อย.
คำถามที่ 3: ขนาดและวัสดุของเวเฟอร์ใดบ้างที่เข้ากันได้กับเตาเผาออกซิเดชัน LPCVD นี้?
A: เตาหลอมนี้รองรับแผ่นเวเฟอร์ขนาด 6 นิ้ว, 8 นิ้ว, และ 12 นิ้ว และสามารถใช้ร่วมกับแผ่นเวเฟอร์โพลีซิลิคอน, ซิลิคอนไนไตรด์, ซิลิคอนออกไซด์, และ SiC ได้ ซึ่งให้ความยืดหยุ่นสำหรับการใช้งานในเซมิคอนดักเตอร์หลากหลายประเภท.
คำถามที่ 4: เตาออกซิเดชัน LPCVD สามารถปรับแต่งให้เหมาะสมกับกระบวนการเฉพาะได้หรือไม่?
A: ใช่ ระบบมีการจัดวางแบบโมดูลาร์ ซึ่งรวมถึงโซนอุณหภูมิที่ปรับได้ การควบคุมการไหลของก๊าซ และโหมดการออกซิเดชัน (แบบแห้งหรือแบบเปียก) ทำให้สามารถตอบสนองความต้องการของกระบวนการที่หลากหลายได้ทั้งในงานวิจัยและการผลิตในระดับอุตสาหกรรม.







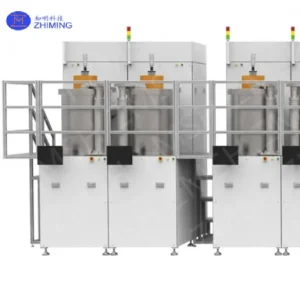
รีวิว
ยังไม่มีบทวิจารณ์