 The HP-1201 Automatic Dicing Machine is a high-performance solution specifically engineered for large-format substrates and multi-piece cutting applications. Designed to meet the evolving demands of advanced semiconductor packaging and substrate processing, the system supports both wafer dicing (up to 12 inches) and large-area workpieces up to 400 × 400 mm.
The HP-1201 Automatic Dicing Machine is a high-performance solution specifically engineered for large-format substrates and multi-piece cutting applications. Designed to meet the evolving demands of advanced semiconductor packaging and substrate processing, the system supports both wafer dicing (up to 12 inches) and large-area workpieces up to 400 × 400 mm.
With its robust gantry structure, opposed dual-spindle configuration, and customizable working platform, the HP-1201 delivers exceptional rigidity, stability, and throughput. It is particularly suitable for applications involving strip materials, multi-die panels, and complex workpiece layouts.
The machine integrates high-precision alignment, intelligent inspection, and flexible processing capabilities, making it an ideal choice for manufacturers seeking both productivity and cutting accuracy.
Key Features
1. Designed for Large-Format Substrates
Unlike conventional dicing systems, the HP-1201 is optimized for large workpieces and packaging substrates:
- Supports up to 400 mm × 400 mm square materials
- Compatible with 12-inch wafers and below
- Ideal for panel-level and advanced packaging processes
This makes it highly adaptable to both semiconductor and emerging packaging technologies.
2. High-Efficiency Multi-Piece Cutting Capability
The system excels in multi-strip and batch processing applications:
- Supports simultaneous placement of multiple workpieces
- Example: up to 5 strips (250 mm × 70 mm) can be processed in one cycle
- Significantly improves throughput and reduces handling time
This capability is especially valuable for high-volume production environments.
3. Opposed Dual-Spindle System for Productivity
The HP-1201 features a dual-spindle structure with a spindle spacing of ≤ 22 mm:
- Enables parallel or sequential cutting operations
- Reduces idle travel distance
- Increases cutting efficiency and overall throughput
Combined with high-speed spindle rotation (up to 60,000 rpm), the system ensures fast and precise material separation.
4. Gantry Structure for Superior Stability
The machine adopts a high-rigidity gantry design:
- Enhanced structural stability during high-speed operation
- Reduced vibration for improved cutting accuracy
- Suitable for precision dicing of brittle materials
This ensures consistent performance even under demanding processing conditions.
5. Advanced Alignment and Inspection System
Equipped with a dual-microscope configuration:
- Enables fast and accurate automatic alignment
- Supports high-resolution kerf inspection
- Improves cutting consistency and reduces defects
This is critical for maintaining tight tolerances in semiconductor manufacturing.
6. Optional Sub-CT Blade Dressing Function
The optional Sub-CT assisted blade dressing function helps maintain optimal blade condition:
- Reduces edge chipping and surface defects
- Extends blade service life
- Improves overall cutting quality
7. Optional Deep-Cut Cooling System
An optional deep-cut cooling water system is available:
- Enhances cooling efficiency during cutting
- Reduces thermal damage to materials
- Improves surface quality and cutting precision
Technical Specifications
| Parameter | Specification |
|---|---|
| Spindle Power | 1.8 kW |
| Spindle Speed | 6000 – 60000 rpm |
| X-axis Travel | 420 mm |
| X-axis Speed | 0.1 – 1000 mm/s |
| X-axis Resolution | 0.001 mm |
| Y1/Y2 Travel | 420 mm |
| Y-axis Resolution | 0.0001 mm |
| Positioning Accuracy | 0.002 mm |
| Accumulated Error | 0.003 / 400 mm |
| Z1/Z2 Travel | 13 mm |
| Repeatability | 0.001 mm |
| Theta Rotation | 380° ± 5° |
| Angular Accuracy | 1 arc-sec |
| Microscope Magnification | 1.5× (optional) / 0.8× |
| Lighting | Ring light + Coaxial light |
| Max Workpiece (Round) | Ø300 mm |
| Max Workpiece (Square) | 400 × 400 mm |
| Machine Size (W×D×H) | 1450 × 1250 × 1850 mm |
| Weight | 2000 kg |
Applications
The HP-1201 is widely used in advanced manufacturing fields requiring high-precision dicing of large or multiple workpieces:
- Semiconductor wafer dicing (≤ 12 inch)
- Advanced packaging substrates
- Panel-level packaging (PLP)
- LED and optoelectronic materials
- Ceramic and hard brittle materials
- Multi-strip and batch cutting applications
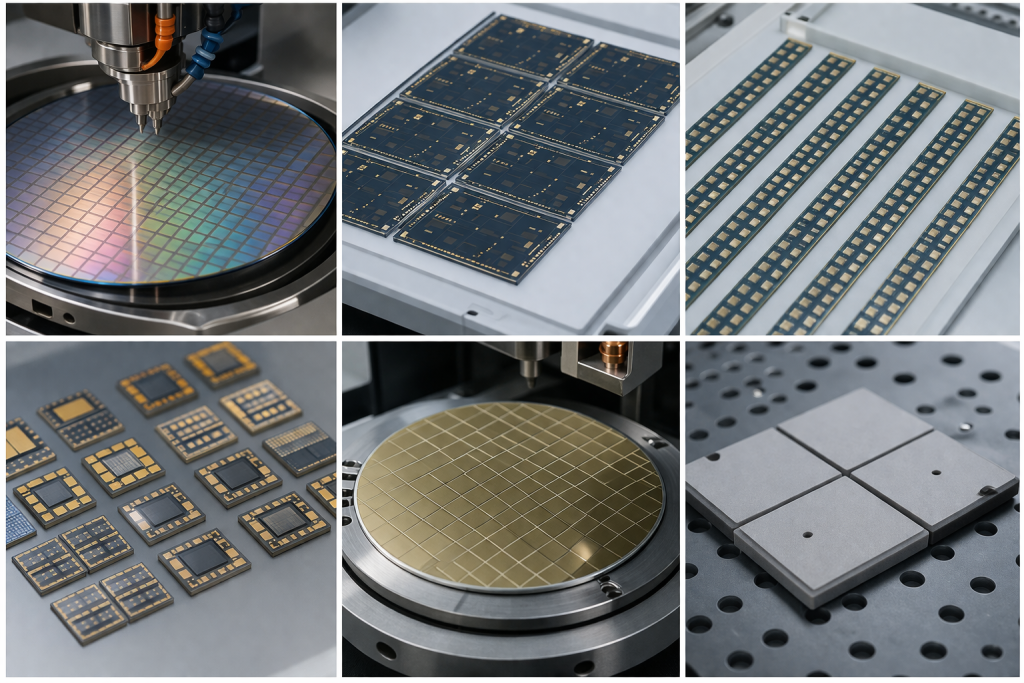
Core Advantages
High Throughput
Multi-piece processing and dual-spindle design significantly increase productivity.
Flexible Processing
Customizable working table allows processing of various shapes and layouts.
Precision & Stability
Gantry structure and advanced alignment system ensure high accuracy and repeatability.
Cost Efficiency
Reduced processing time and improved blade life lower overall operational costs.
Frequently Asked Questions (FAQ)
1. What is the maximum workpiece size supported by the HP-1201?
The HP-1201 supports both wafer and large-format substrates. It can process round wafers up to 12 inches (Ø300 mm) and square workpieces up to 400 × 400 mm. This makes it particularly suitable for advanced packaging and panel-level applications.
2. Is the HP-1201 suitable for multi-piece or strip cutting applications?
Yes. The HP-1201 is specifically optimized for multi-piece and strip cutting. It can process multiple strips in a single cycle—for example, up to 5 pieces of 250 mm × 70 mm strips—significantly improving throughput and reducing handling time in batch production.
3. How does the machine ensure cutting accuracy and stability?
The HP-1201 ensures high precision through a combination of:
- High-rigidity gantry structure for stable operation
- Dual-microscope system for accurate alignment and inspection
- High-resolution motion control (up to 0.0001 mm resolution)
- Dual-spindle configuration for balanced and efficient cutting
These features work together to deliver consistent cutting quality, minimal chipping, and reliable performance in demanding applications.





Reviews
There are no reviews yet.