 オートマチックダイシングマシンHP-1201は、大判基板およびマルチピースカットアプリケーション向けに特別に設計された高性能ソリューションです。最先端半導体パッケージングや基板加工の進化する要求に応えるべく設計された本システムは、ウェーハダイシング(最大12インチ)と最大400×400 mmの大面積ワークの両方をサポートします。.
オートマチックダイシングマシンHP-1201は、大判基板およびマルチピースカットアプリケーション向けに特別に設計された高性能ソリューションです。最先端半導体パッケージングや基板加工の進化する要求に応えるべく設計された本システムは、ウェーハダイシング(最大12インチ)と最大400×400 mmの大面積ワークの両方をサポートします。.
堅牢なガントリー構造、対向2スピンドル構成、カスタマイズ可能な作業プラットフォームにより、HP-1201は卓越した剛性、安定性、スループットを実現します。特に、ストリップ材、マルチダイパネル、複雑なワークレイアウトを含むアプリケーションに適しています。.
高精度アライメント、インテリジェント検査、フレキシブルな加工機能を統合し、生産性と切断精度の両方を求めるメーカーにとって理想的な選択肢となっている。.
主な特徴
1.ラージフォーマット用設計
従来のダイシングシステムとは異なり、HP-1201は大型ワークやパッケージング基板に最適化されています:
- 最大400mm×400mm角の素材に対応
- 12インチ以下のウェハーに対応
- パネルレベルおよび高度なパッケージング工程に最適
このため、半導体と新興パッケージング技術の両方に高い適応性を持つ。.
2.高効率マルチピース切断能力
このシステムは、マルチストリップやバッチ処理アプリケーションに優れています:
- 複数ワークの同時配置に対応
- 例:1サイクルで最大5本のストリップ(250 mm × 70 mm)を処理できます。
- スループットを大幅に改善し、処理時間を短縮
この機能は、大量生産環境では特に価値がある。.
3.生産性を高める対向2スピンドルシステム
HP-1201は、スピンドル間隔≤22 mmのデュアルスピンドル構造を採用:
- パラレルまたはシーケンシャル切断が可能
- アイドル走行距離の短縮
- 切断効率と全体的なスループットを向上
高速スピンドル回転(最大60,000 rpm)と組み合わせることで、このシステムは迅速かつ正確な材料分離を実現します。.
4.安定性に優れたガントリー構造
機械は高剛性ガントリー設計を採用:
- 高速走行時の構造安定性が向上
- 振動を低減し、切断精度を向上
- 脆性材料の精密ダイシングに最適
これにより、厳しい加工条件下でも安定した性能を発揮します。.
5.高度なアライメントと検査システム
デュアル顕微鏡を装備:
- 高速で正確な自動アライメントが可能
- 高解像度カーフ検査に対応
- 切断の安定性を向上させ、不良品を減らす
これは、半導体製造において厳しい公差を維持するために非常に重要である。.
6.オプションのサブCTブレードドレッシング機能
オプションのSub-CTアシストブレードドレッシング機能は、ブレードの状態を最適に保つのに役立ちます:
- エッジの欠けや表面の欠陥を低減
- ブレードの寿命を延ばす
- 全体的な切断品質の向上
7.オプションのディープカット冷却システム
オプションでディープカット冷却水システムも用意されている:
- 切断時の冷却効率を向上
- 素材への熱ダメージを軽減
- 表面品質と切断精度の向上
技術仕様
| パラメータ | 仕様 |
|---|---|
| スピンドル・パワー | 1.8 kW |
| 主軸回転数 | 6000 - 60000 rpm |
| X軸トラベル | 420 mm |
| X軸速度 | 0.1 - 1000 mm/s |
| X軸分解能 | 0.001 mm |
| Y1/Y2 トラベル | 420 mm |
| Y軸分解能 | 0.0001 mm |
| ポジショニング精度 | 0.002 mm |
| 累積エラー | 0.003 / 400 mm |
| Z1/Z2 トラベル | 13 mm |
| 再現性 | 0.001 mm |
| シータ・ローテーション | 380° ± 5° |
| 角度精度 | 1秒角 |
| 顕微鏡の倍率 | 1.5倍(オプション)/0.8倍 |
| 照明 | リングライト+同軸ライト |
| 最大ワーク(円形) | Ø300 mm |
| 最大ワーク(正方形) | 400 × 400 mm |
| 機械サイズ(W×D×H) | 1450 × 1250 × 1850 mm |
| 重量 | 2000キロ |
アプリケーション
HP-1201は、大型ワークや複数ワークの高精度ダイシングを必要とする先端製造分野で広く使用されています:
- 半導体ウェーハダイシング(12インチ以下)
- アドバンスト・パッケージング基板
- パネルレベルパッケージング(PLP)
- LEDおよびオプトエレクトロニクス材料
- セラミックおよび硬脆性材料
- マルチストリップおよびバッチ切断アプリケーション
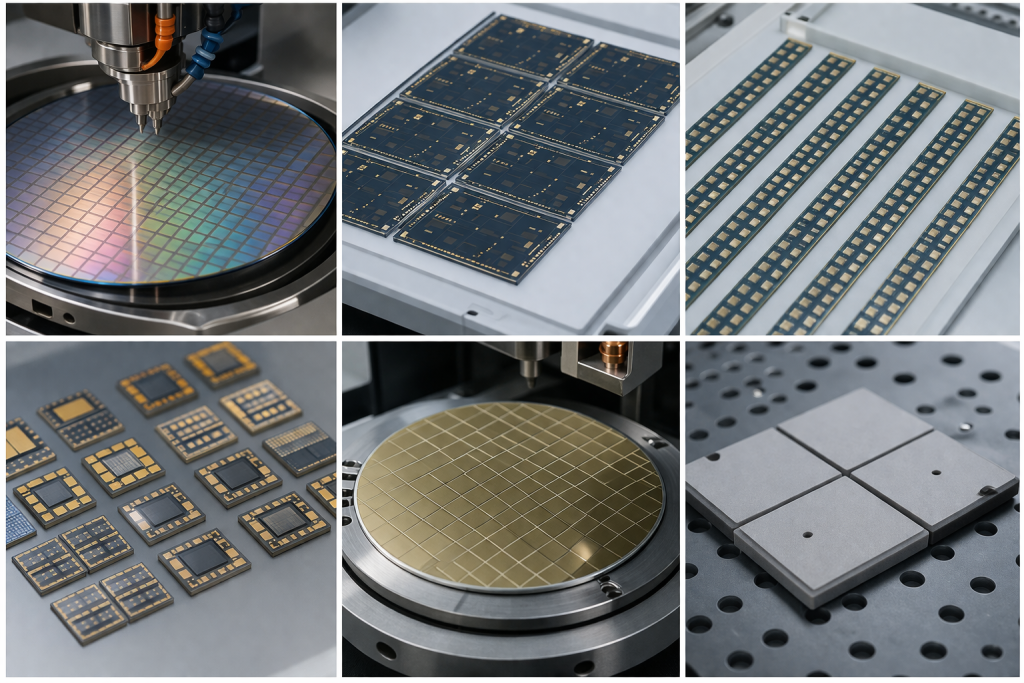
コアの利点
高スループット
マルチピース加工とデュアルスピンドル設計により、生産性が大幅に向上。.
柔軟な加工
カスタマイズ可能な作業テーブルにより、様々な形状やレイアウトの加工が可能。.
精度と安定性
ガントリー構造と高度なアライメントシステムにより、高い精度と再現性を確保。.
コスト効率
処理時間の短縮とブレード寿命の向上により、全体的な運用コストを削減。.
よくある質問(FAQ)
1.HP-1201がサポートする最大ワークサイズは?
HP-1201は、ウェーハと大判基板の両方に対応しています。最大12インチ(Ø300 mm)までの円形ウェーハと、最大400 × 400 mmまでの正方形ワークの加工が可能です。このため、高度なパッケージングやパネルレベルのアプリケーションに特に適しています。.
2.HP-1201は、マルチピースやストリップの切断に適していますか?
HP-1201は、特にマルチピースおよびストリップ切断用に最適化されています。例えば、250 mm×70 mmのストリップを最大5枚まで、1サイクルで複数のストリップを処理することができ、バッチ生産におけるスループットの大幅な向上と処理時間の短縮を実現します。.
3.機械はどのようにして切断精度と安定性を確保しているのですか?
HP-1201は、以下の組み合わせにより高精度を保証する:
- 高剛性ガントリー構造による安定した動作
- 正確なアライメントと検査のためのデュアル・マイクロスコープ・システム
- 高分解能モーションコントロール(最大0.0001 mmの分解能)
- バランスのとれた効率的な切断を実現するデュアルスピンドル構成
これらの特徴が相まって、要求の厳しい用途において、安定した切断品質、最小限のチッピング、信頼性の高い性能を実現します。.





レビュー
レビューはまだありません。