![]() Die vollautomatische HP-1221 Wafer Dicing Machine ist eine hocheffiziente, präzisionsgefertigte Lösung für die Vereinzelung von Halbleiterwafern. Dieses System unterstützt Wafer bis zu 12 Zoll (300 mm) und integriert fortschrittliche Automatisierung, Zweispindel-Schneidtechnologie und intelligente Ausrichtsysteme, um überragende Schneidgenauigkeit, Durchsatz und Konsistenz zu gewährleisten.
Die vollautomatische HP-1221 Wafer Dicing Machine ist eine hocheffiziente, präzisionsgefertigte Lösung für die Vereinzelung von Halbleiterwafern. Dieses System unterstützt Wafer bis zu 12 Zoll (300 mm) und integriert fortschrittliche Automatisierung, Zweispindel-Schneidtechnologie und intelligente Ausrichtsysteme, um überragende Schneidgenauigkeit, Durchsatz und Konsistenz zu gewährleisten.
Der HP-1221 wurde für moderne Halbleiterfertigungsumgebungen entwickelt und ermöglicht einen vollautomatischen Arbeitsablauf - vom Laden und Ausrichten der Wafer bis hin zum präzisen Schneiden, gefolgt von integrierter Reinigung und Trocknung. Dies reduziert manuelle Eingriffe erheblich, verbessert die Ausbeute und sorgt für wiederholbare Prozessstabilität.
Mit seiner kompakten Grundfläche und seiner robusten Bauweise eignet sich der HP-1221 sowohl für Produktionslinien mit hohen Stückzahlen als auch für spezielle Anwendungen, die hohe Präzision und Zuverlässigkeit erfordern.
Wesentliche Merkmale
1. Zwei Spindeln mit gegenüberliegender Struktur für hohen Wirkungsgrad
Die Maschine verfügt über eine fortschrittliche, gegenläufige Zweispindelkonfiguration. Durch die Verringerung des Abstands zwischen den beiden Spindeln minimiert das System die Leerlaufbewegung und verbessert die Schneideffizienz erheblich. Diese Konstruktion ermöglicht einen kontinuierlichen Betrieb und reduziert die Zykluszeit, was sie ideal für Produktionsumgebungen mit hohem Durchsatz macht.
2. Vollständig automatisierter integrierter Prozess
Der HP-1221 unterstützt einen vollständig automatisierten Prozess, einschließlich:
- Automatisches Laden und Entladen von Wafern
- Hochpräzise Ausrichtung
- Kontrollierter Würfelvorgang
- Integrierte Reinigung und Trocknung
Dieser Automatisierungsgrad steigert nicht nur die Produktivität, sondern verringert auch die Abhängigkeit vom Bediener und die durch ihn verursachten Fehler.
3. Hochpräzises Ausrichtungs- und Inspektionssystem
Das System ist mit einer Doppelmikroskop-Konfiguration (hohe und niedrige Vergrößerung) ausgestattet und gewährleistet:
- Schnelle und genaue Ausrichtung der Wafer
- Verifizierung des Schneidwegs in Echtzeit
- Hochauflösende Schnittfugeninspektion
Diese Eigenschaft ist entscheidend für die Einhaltung enger Toleranzen und die Gewährleistung einer gleichbleibenden Schnittqualität, insbesondere bei modernen Halbleiterbauteilen.
4. Sub-C/T Assisted Blade Dressing Funktion
Die integrierte Sub-C/T Klingenabrichtfunktion hilft, die optimale Klingenschärfe während des Betriebs zu erhalten. Das Ergebnis ist:
- Verbesserte Schnittflächenqualität
- Geringere Abplatzungen und Mikrorisse
- Verlängerte Lebensdauer der Klinge
Letztlich trägt dies zu niedrigeren Betriebskosten und einer höheren Produktausbeute bei.
5. Optionale Zwei-Fluid-Reinigungsdüse
Eine optionale Luft-Wasser-Doppelflüssigkeitsdüse kann im Schneidbereich installiert werden, um die Reinigungsleistung nach dem Schneiden zu verbessern. Dies gewährleistet eine effektive Entfernung von Ablagerungen und Partikeln, verbessert die Sauberkeit der Wafer und verringert das Kontaminationsrisiko in nachgelagerten Prozessen.
Technische Daten
| Parameter | Spezifikation |
|---|---|
| Spindelleistung / Drehzahl | 1,8 kW / 2,2 kW (optional), 6000-60000 U/min |
| Flansch Größe | 2 Zoll |
| Maximale Werkstückgröße | Rund: Ø300 mm / Quadratisch: 254 mm × 254 mm |
| Mikroskop-Konfiguration | Hohe Vergrößerung: 7,5× / Niedrige Vergrößerung: 0,75× (optional) |
| Abmessungen der Maschine (B × T × H) | 1285 mm × 1590 mm × 1860 mm |
Anwendungen
Das HP-1221 wurde entwickelt, um die anspruchsvollen Anforderungen verschiedener Anwendungen in der Halbleiterindustrie und bei hochentwickelten Materialien zu erfüllen, darunter:
- Würfeln von Siliziumwafern für integrierte Schaltungen (ICs)
- Bearbeitung von Wafern für Leistungsbauelemente (z. B. SiC, GaN)
- Herstellung von MEMS-Bauteilen
- Schneiden von LED- und optoelektronischen Wafern
- Fortgeschrittene Packaging- und Wafer-Level-Packaging-Prozesse
Dank seiner Kompatibilität mit Wafern bis zu 12 Zoll eignet es sich sowohl für ausgereifte als auch für fortgeschrittene Fertigungsknoten.
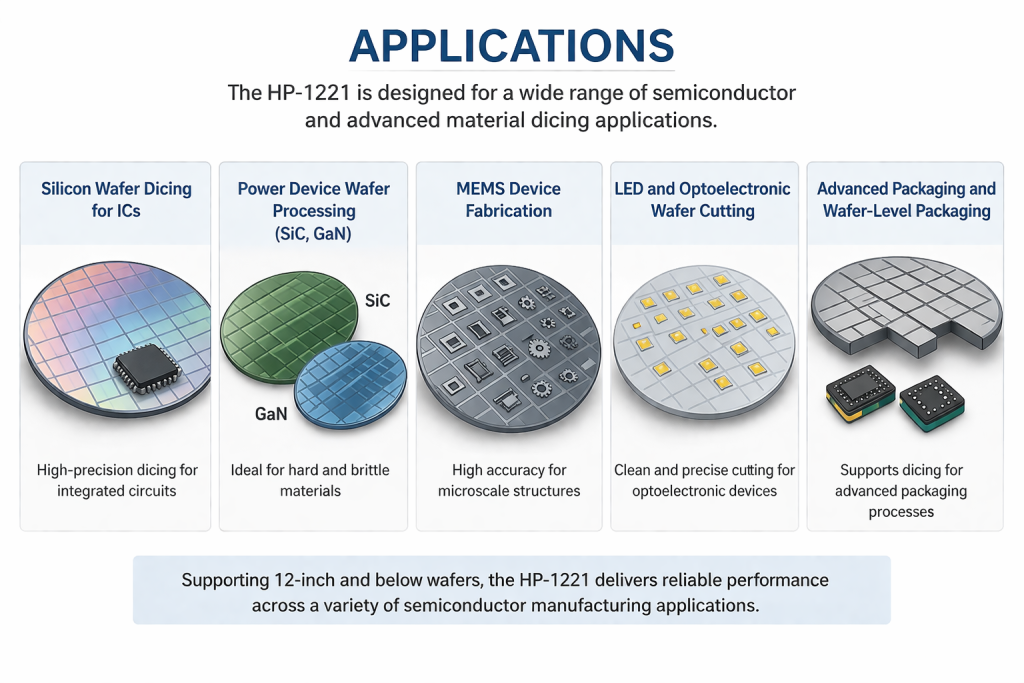
Leistungsvorteile
Verbesserte Ausbeute und Verlässlichkeit
Die präzise Ausrichtung und die stabile Spindelleistung sorgen für minimale Kantenausbrüche und hochwertige Schnittflächen, was direkt zu einer verbesserten Geräteausbeute beiträgt.
Hoher Durchsatz
Das zweispindlige Design und die reduzierte Zykluszeit ermöglichen eine schnellere Bearbeitung ohne Beeinträchtigung der Genauigkeit, wodurch sich das System ideal für die Großserienproduktion eignet.
Prozess-Stabilität
Integrierte Automatisierungs- und intelligente Steuerungssysteme sorgen für eine gleichbleibende Leistung über lange Produktionszyklen hinweg, verringern die Variabilität und verbessern die Wiederholbarkeit.
Kosteneffizienz
Funktionen wie das Abrichten der Klingen und die effiziente Reinigung reduzieren den Verbrauch von Verbrauchsmaterialien und die Wartungshäufigkeit, was die Betriebskosten insgesamt senkt.
Warum HP-1221 wählen?
Der HP-1221 ist eine zuverlässige und skalierbare Wafer-Dicing-Lösung für Hersteller, die eine solche Lösung suchen:
- Hohe Präzision bei der Wafervereinzelung
- Automatisierte, bedienerunabhängige Prozesse
- Kompatibilität mit fortschrittlichen Materialien
- Langfristige Kosteneffizienz und stabile Leistung
Seine Kombination aus fortschrittlicher Technik, Automatisierung und benutzerorientiertem Design macht ihn zu einer wertvollen Ergänzung für jede Halbleiterfertigungslinie.
FAQ
1. Welche Arten von Wafern kann das HP-1221 verarbeiten?
Das HP-1221 ist für eine breite Palette von Wafer-Materialien ausgelegt, die in der Halbleiter- und modernen Elektronikfertigung verwendet werden. Dazu gehören Silizium (Si), Siliziumkarbid (SiC), Galliumnitrid (GaN) und andere Verbindungshalbleitermaterialien.
Mit seiner hohen Spindeldrehzahl (bis zu 60.000 U/min) und seiner stabilen Schnittleistung ist das System in der Lage, sowohl normale als auch harte, spröde Materialien zu bearbeiten und dabei eine hervorragende Kantenqualität und minimale Ausbrüche zu gewährleisten.
2. Wie verbessert das Doppelspindelsystem die Produktionseffizienz?
Die gegenläufige Doppelspindelstruktur reduziert die unproduktiven Bewegungen während des Betriebs erheblich. Durch die Minimierung des Abstands zwischen den Schneidachsen kann das System schnellere Übergänge und kontinuierliche Schneidvorgänge durchführen.
Dies führt zu:
- Kürzere Zykluszeiten
- Höherer Durchsatz
- Verbesserte Nutzung der Ausrüstung
Im Vergleich zu einspindligen Systemen bietet die HP-1221 eine effizientere Lösung für hochvolumige Wafer-Dicing-Anwendungen.
3. Wie gewährleistet die Maschine Schnittgenauigkeit und Qualität?
Der HP-1221 verfügt über eine Vielzahl von Funktionen, die Präzision und Konsistenz garantieren, darunter:
- Doppelmikroskopsystem für genaue Ausrichtung und Echtzeitprüfung
- Vibrationsarme Hochgeschwindigkeitsspindel für stabilen Schnitt
- Sub-C/T Klingenabrichtfunktion zur Erhaltung der Klingenschärfe
- Optionales Zweiflüssigkeits-Reinigungssystem zur Entfernung von Verschmutzungen und zur Vermeidung von Kontaminationen
Diese kombinierten Technologien tragen dazu bei, enge Toleranzen, saubere Schnittlinien und eine hohe Wiederholgenauigkeit zu gewährleisten, die für die Aufrechterhaltung der Ausbeute in der Halbleiterfertigung unerlässlich sind.




Rezensionen
Es gibt noch keine Rezensionen.