 Die automatische Würfelschneidemaschine HP-1201 ist eine Hochleistungslösung, die speziell für großformatige Substrate und mehrteilige Schneidanwendungen entwickelt wurde. Das System wurde entwickelt, um den wachsenden Anforderungen des modernen Halbleiter-Packaging und der Substratverarbeitung gerecht zu werden. Es unterstützt sowohl das Trennen von Wafern (bis zu 12 Zoll) als auch großflächige Werkstücke bis zu 400 × 400 mm.
Die automatische Würfelschneidemaschine HP-1201 ist eine Hochleistungslösung, die speziell für großformatige Substrate und mehrteilige Schneidanwendungen entwickelt wurde. Das System wurde entwickelt, um den wachsenden Anforderungen des modernen Halbleiter-Packaging und der Substratverarbeitung gerecht zu werden. Es unterstützt sowohl das Trennen von Wafern (bis zu 12 Zoll) als auch großflächige Werkstücke bis zu 400 × 400 mm.
Mit ihrer robusten Gantry-Struktur, der gegenüberliegenden Doppelspindelkonfiguration und der anpassbaren Arbeitsplattform bietet die HP-1201 eine außergewöhnliche Steifigkeit, Stabilität und Durchsatzleistung. Sie eignet sich besonders für Anwendungen mit Bandmaterialien, Mehrfachplatten und komplexen Werkstücklayouts.
Die Maschine integriert hochpräzise Ausrichtung, intelligente Inspektion und flexible Bearbeitungsmöglichkeiten und ist damit die ideale Wahl für Hersteller, die sowohl Produktivität als auch Schnittgenauigkeit suchen.
Wesentliche Merkmale
1. Konzipiert für großformatige Substrate
Im Gegensatz zu herkömmlichen Würfelsystemen ist das HP-1201 für große Werkstücke und Verpackungssubstrate optimiert:
- Geeignet für quadratische Materialien bis zu 400 mm × 400 mm
- Kompatibel mit 12-Zoll-Wafern und darunter
- Ideal für Panel-Level und fortschrittliche Verpackungsprozesse
Dadurch ist es sowohl für Halbleiter als auch für neue Verpackungstechnologien bestens geeignet.
2. Hocheffizientes Schneiden in mehreren Teilen
Das System eignet sich hervorragend für Mehrstreifen- und Stapelverarbeitungsanwendungen:
- Unterstützt die gleichzeitige Platzierung von mehreren Werkstücken
- Beispiel: bis zu 5 Streifen (250 mm × 70 mm) können in einem Zyklus verarbeitet werden
- Erhebliche Verbesserung des Durchsatzes und Reduzierung der Bearbeitungszeit
Diese Fähigkeit ist besonders wertvoll für hochvolumige Produktionsumgebungen.
3. Gegenüberliegendes Doppelspindelsystem für mehr Produktivität
Das HP-1201 verfügt über eine Doppelspindelstruktur mit einem Spindelabstand von ≤ 22 mm:
- Ermöglicht parallele oder sequentielle Schneidvorgänge
- Reduziert den Leerlaufweg
- Erhöht die Schneideleistung und den Gesamtdurchsatz
In Verbindung mit der hohen Drehzahl der Spindel (bis zu 60.000 U/min) gewährleistet das System eine schnelle und präzise Materialtrennung.
4. Gantry-Struktur für überlegene Stabilität
Die Maschine ist mit einem hochsteifen Portal ausgestattet:
- Verbesserte strukturelle Stabilität im Hochgeschwindigkeitsbetrieb
- Reduzierte Vibration für verbesserte Schnittgenauigkeit
- Geeignet zum präzisen Schneiden von spröden Materialien
Dies gewährleistet eine konstante Leistung auch unter anspruchsvollen Verarbeitungsbedingungen.
5. Fortschrittliches Ausrichtungs- und Inspektionssystem
Ausgestattet mit einer Doppelmikroskop-Konfiguration:
- Ermöglicht eine schnelle und genaue automatische Ausrichtung
- Unterstützt hochauflösende Schnittspaltinspektion
- Verbessert die Schnittkonsistenz und reduziert Fehler
Dies ist entscheidend für die Einhaltung enger Toleranzen in der Halbleiterfertigung.
6. Optionale Sub-CT-Klingenabrichtfunktion
Die optionale Abrichtfunktion Sub-CT hilft, den optimalen Zustand der Klinge zu erhalten:
- Verringert Kantenabplatzungen und Oberflächenfehler
- Verlängert die Lebensdauer der Klinge
- Verbessert die allgemeine Schnittqualität
7. Optionales Deep-Cut-Kühlsystem
Optional ist ein Kühlwassersystem mit tiefem Einschnitt erhältlich:
- Verbessert die Kühlleistung beim Schneiden
- Verringert thermische Schäden an Materialien
- Verbessert Oberflächenqualität und Schnittpräzision
Technische Daten
| Parameter | Spezifikation |
|---|---|
| Spindel Leistung | 1,8 kW |
| Spindeldrehzahl | 6000 - 60000 U/min |
| X-Achse Verfahrweg | 420 mm |
| X-Achse Geschwindigkeit | 0,1 - 1000 mm/s |
| X-Achse Auflösung | 0,001 mm |
| Y1/Y2 Reisen | 420 mm |
| Y-Achse Auflösung | 0,0001 mm |
| Positionierungsgenauigkeit | 0,002 mm |
| Kumulierter Fehler | 0,003 / 400 mm |
| Z1/Z2 Reisen | 13 mm |
| Reproduzierbarkeit | 0,001 mm |
| Theta-Drehung | 380° ± 5° |
| Winkelgenauigkeit | 1 Bogensekunde |
| Mikroskopische Vergrößerung | 1,5× (optional) / 0,8× |
| Beleuchtung | Ringlicht + Koaxiallicht |
| Max Werkstück (rund) | Ø300 mm |
| Max Werkstück (quadratisch) | 400 × 400 mm |
| Größe der Maschine (B×T×H) | 1450 × 1250 × 1850 mm |
| Gewicht | 2000 kg |
Anwendungen
Die HP-1201 wird häufig in fortschrittlichen Fertigungsbereichen eingesetzt, die eine hochpräzise Zerlegung von großen oder mehreren Werkstücken erfordern:
- Zerteilen von Halbleiterwafern (≤ 12 Zoll)
- Moderne Verpackungssubstrate
- Verpackung auf Paneelebene (PLP)
- LED und optoelektronische Materialien
- Keramische und hart-spröde Materialien
- Mehrstreifen- und Stapelschneidanwendungen
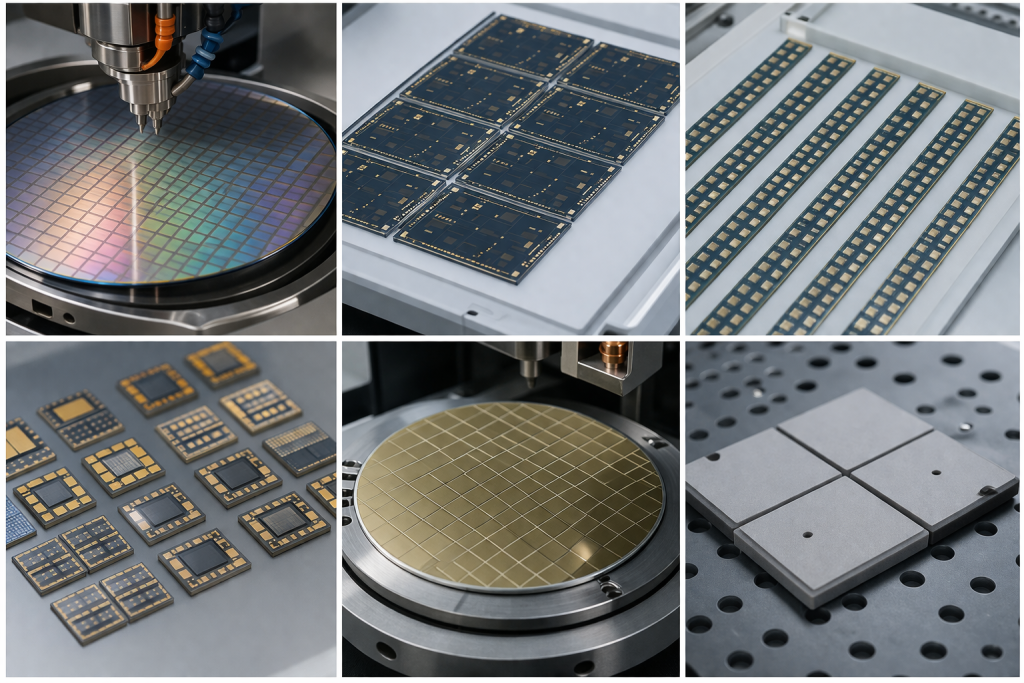
Wesentliche Vorteile
Hoher Durchsatz
Mehrteilige Bearbeitung und zweispindlige Ausführung erhöhen die Produktivität erheblich.
Flexible Verarbeitung
Der anpassbare Arbeitstisch ermöglicht die Bearbeitung verschiedener Formen und Layouts.
Präzision und Stabilität
Die Gantry-Struktur und das fortschrittliche Ausrichtungssystem gewährleisten hohe Genauigkeit und Wiederholbarkeit.
Kosteneffizienz
Geringere Bearbeitungszeiten und eine längere Lebensdauer der Klingen senken die Gesamtbetriebskosten.
Häufig gestellte Fragen (FAQ)
1. Welches ist die maximale Werkstückgröße, die das HP-1201 unterstützt?
Der HP-1201 unterstützt sowohl Wafer als auch großformatige Substrate. Er kann runde Wafer bis zu 12 Zoll (Ø300 mm) und quadratische Werkstücke bis zu 400 × 400 mm verarbeiten. Damit eignet er sich besonders für fortschrittliche Verpackungs- und Panel-Anwendungen.
2. Ist das HP-1201 für das Schneiden von mehreren Teilen oder Streifen geeignet?
Ja. Der HP-1201 ist speziell für das Schneiden von mehreren Stücken und Streifen optimiert. Sie kann mehrere Streifen in einem einzigen Zyklus verarbeiten - zum Beispiel bis zu 5 Stück 250 mm × 70 mm große Streifen -, was den Durchsatz deutlich erhöht und die Bearbeitungszeit in der Serienproduktion reduziert.
3. Wie gewährleistet die Maschine Schnittgenauigkeit und Stabilität?
Der HP-1201 gewährleistet hohe Präzision durch eine Kombination aus:
- Hochstabile Portalkonstruktion für stabilen Betrieb
- Doppelmikroskopsystem für genaue Ausrichtung und Prüfung
- Hochauflösende Bewegungssteuerung (bis zu 0,0001 mm Auflösung)
- Zweispindelkonfiguration für ausgewogenes und effizientes Schneiden
Diese Merkmale sorgen gemeinsam für eine gleichbleibende Schnittqualität, minimale Ausbrüche und zuverlässige Leistung bei anspruchsvollen Anwendungen.





Rezensionen
Es gibt noch keine Rezensionen.