![]() HP-1221 全自動晶圓切割機是專為半導體晶圓切割製程所設計的高效率、精密設計解決方案。此系統可支援最大 12 英吋 (300 公釐) 的晶圓,整合先進的自動化、雙主軸切割技術和智慧型校準系統,提供卓越的切割精確度、產量和一致性。.
HP-1221 全自動晶圓切割機是專為半導體晶圓切割製程所設計的高效率、精密設計解決方案。此系統可支援最大 12 英吋 (300 公釐) 的晶圓,整合先進的自動化、雙主軸切割技術和智慧型校準系統,提供卓越的切割精確度、產量和一致性。.
HP-1221 專為現代半導體製造環境而設計,可實現完全自動化的工作流程 - 從晶圓載入、對齊到精密切割,再到整合式清洗和乾燥。這可大幅減少人工介入、提高良率,並確保可重複的製程穩定性。.
HP-1221 佔地面積小、結構設計堅固,既適用於大批量生產線,也適用於需要高精度和高可靠性的特殊應用。.
主要功能
1.高效率的雙主軸對置結構
本機採用先進的對置雙主軸配置。藉由縮小兩個主軸之間的距離,系統可將閒置移動減至最低,並大幅提升切削效率。此設計可實現連續作業並縮短週期時間,非常適合高產量的生產環境。.
2.全自動化整合流程
HP-1221 支援完整的自動化流程,包括
- 自動裝卸晶圓
- 高精度對準
- 受控制的切割操作
- 整合式清潔與乾燥
這種自動化程度不僅能提高生產力,還能減少操作員的依賴性和人為錯誤。.
3.高精度校準和檢測系統
配備雙顯微鏡配置(高倍率和低倍率),可確保系統:
- 快速精確的晶圓對位
- 即時切割路徑驗證
- 高解析度切口檢測
此功能對於保持嚴格的公差和確保一致的切割品質至關重要,特別是對於先進的半導體裝置。.
4.Sub-C/T 輔助刀片修整功能
整合式 Sub-C/T 刀片修整功能有助於在操作過程中保持最佳的刀片鋒利度。其結果是
- 改善切削表面品質
- 減少崩裂和微裂縫
- 延長刀片壽命
最終,這有助於降低營運成本和提高產品良率。.
5.選購的雙流體清洗噴嘴
切割區可安裝選購的氣水雙流體噴嘴,以提升切割後的清潔效能。這可確保有效清除碎屑和微粒,提高晶圓清潔度,降低下游製程的污染風險。.
技術規格
| 參數 | 規格 |
|---|---|
| 主軸馬力/轉速 | 1.8 kW / 2.2 kW(選配),6000-60000 rpm |
| 凸緣尺寸 | 2 英寸 |
| 最大工件尺寸 | 圓形:Ø300 mm / Square: 254 mm × 254 mm |
| 顯微鏡配置 | 高倍率:7.5× / 低放大倍率:0.75 倍 (選購) |
| 機器尺寸 (寬 × 深 × 高) | 1285 公釐 × 1590 公釐 × 1860 公釐 |
應用
HP-1221 專為滿足各種半導體和先進材料應用的嚴苛要求而設計,包括
- 用於集成電路 (IC) 的矽晶圓切割
- 功率元件晶圓處理 (如 SiC、GaN)
- 微機電裝置製造
- LED 與光電晶圓切割
- 先進封裝與晶圓級封裝製程
它與最大 12 英吋的晶圓相容,因此適用於成熟和先進製造節點。.
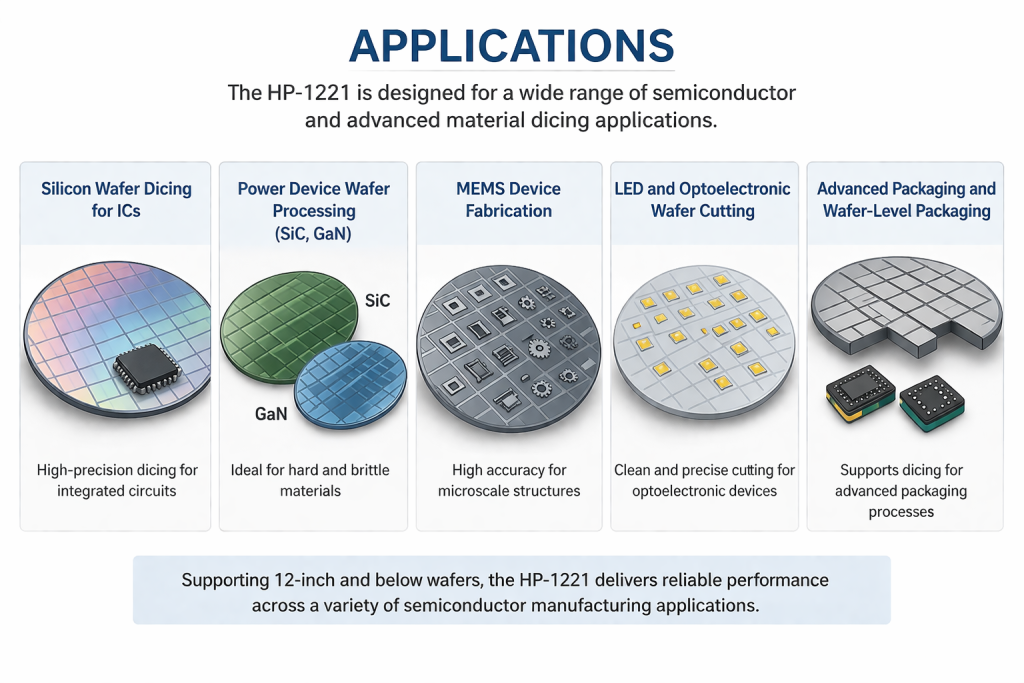
性能優勢
提高產量和可靠性
精準的對齊與穩定的主軸性能可確保最小的邊緣崩角與高品質的切割表面,直接有助於提高裝置良率。.
高產量
雙主軸設計與縮短的週期時間,可在不影響精度的情況下加快加工速度,使該系統成為大規模生產的理想選擇。.
製程穩定性
整合式自動化與智慧型控制系統可確保長生產週期內的一致效能,減少變異性並提昇重複性。.
成本效益
刀片修整和高效清潔等功能可減少耗材用量和維護頻率,降低整體營運成本。.
為何選擇 HP-1221
HP-1221 為製造商尋求可靠且可擴充的晶圓切割解決方案:
- 晶圓單一化的高精度
- 獨立於操作員的自動化流程
- 與先進材料相容
- 長期的成本效益與穩定的效能
它結合了先進的工程技術、自動化和以使用者為導向的設計,使其成為任何半導體製造產線的重要組成部分。.
常見問題
1.HP-1221 可以處理哪些類型的晶圓?
HP-1221 專為處理半導體和先進電子製造中使用的各種晶圓材料而設計。這些材料包括矽 (Si)、碳化矽 (SiC)、氮化鎵 (GaN) 以及其他化合物半導體材料。.
憑藉其高主軸轉速(高達 60,000 rpm)和穩定的切削性能,該系統既能加工標準材料,也能加工硬脆材料,同時保持極佳的邊緣品質和最小的崩角。.
2.雙主軸系統如何提高生產效率?
對向雙主軸結構可大幅減少作業過程中的非生產性移動。藉由最小化切削軸之間的距離,系統可執行更快速的轉換與連續切削作業。.
這會導致
- 更短的週期時間
- 更高的產能
- 提高設備利用率
相較於單主軸系統,HP-1221 為大批量晶圓切割應用提供更有效率的解決方案。.
3.機器如何確保切割精度和品質?
HP-1221 整合了多種功能以保證精確度和一致性,包括
- 雙顯微鏡系統可進行精確校準和即時檢測
- 高速、低振動主軸,提供穩定切削
- Sub-C/T 刀片修整功能可保持刀片的銳利度
- 選購的雙流體清洗系統可清除碎屑並防止污染
這些技術的結合有助於確保嚴苛的公差、乾淨的切斷線以及高重複性,這些都是維持半導體製造良率的必要條件。.



商品評價
目前沒有評價。