Lò oxy hóa LPCVD 6/8/12 inch là một thiết bị sản xuất bán dẫn tiên tiến, được thiết kế để lắng đọng màng mỏng một cách chính xác và đồng đều. Thiết bị này được ứng dụng rộng rãi trong việc tạo ra các lớp polysilicon, nitrua silic và oxit silic chất lượng cao trên các tấm wafer, đảm bảo hiệu suất ổn định cho các linh kiện bán dẫn công suất, chất nền tiên tiến và các ứng dụng đòi hỏi độ chính xác cao khác.
Thiết bị này kết hợp công nghệ lắng đọng áp suất thấp tiên tiến, hệ thống điều khiển nhiệt độ thông minh và thiết kế quy trình siêu sạch để đạt được độ đồng đều vượt trội của màng mỏng cùng năng suất cao. Cấu trúc lò phản ứng dạng đứng của thiết bị cho phép xử lý theo lô hiệu quả, trong khi quy trình lắng đọng nhiệt giúp tránh được hư hỏng do plasma gây ra, khiến nó trở thành lựa chọn lý tưởng cho các quy trình quan trọng như hình thành lớp điện môi cổng, lớp đệm ứng suất và các lớp oxit bảo vệ.

Những ưu điểm nổi bật
- Phương pháp lắng đọng màng mỏng có độ đồng đều cao: Môi trường áp suất thấp (0,1–10 Torr) đảm bảo độ đồng đều giữa các tấm wafer và trong cùng một tấm wafer ở mức ±1,51 TP3T, yếu tố quan trọng đối với việc sản xuất các thiết bị hiệu suất cao.
- Thiết kế lò phản ứng thẳng đứng: Xử lý được 150–200 tấm wafer mỗi mẻ, giúp nâng cao năng suất và hiệu quả sản xuất trong quá trình chế tạo bán dẫn quy mô công nghiệp.
- Quy trình lắng đọng nhiệt (500–900°C): Cung cấp quá trình lắng đọng nhẹ nhàng, không sử dụng plasma để bảo vệ các chất nền nhạy cảm và duy trì chất lượng màng cao.
- Điều khiển nhiệt độ thông minh: Giám sát và điều chỉnh theo thời gian thực với độ chính xác ±1°C để đảm bảo kết quả ổn định và lặp lại được.
- Buồng xử lý siêu sạch: Giảm thiểu ô nhiễm hạt, phù hợp với SiC và các vật liệu tấm wafer tiên tiến khác.
- Cấu hình có thể tùy chỉnh: Thiết kế linh hoạt đáp ứng các yêu cầu quy trình khác nhau, bao gồm quá trình oxy hóa khô hoặc ướt và các kích thước tấm wafer khác nhau.
Thông số kỹ thuật
| Tính năng | Thông số kỹ thuật |
|---|---|
| Kích thước tấm wafer | 6/8/12 inch |
| Các vật liệu tương thích | Polysilicon, nitrua silic, oxit silic |
| Loại oxy hóa | Oxy khô / Oxy ướt (DCE, HCl) |
| Phạm vi nhiệt độ quá trình | 500°C–900°C |
| Khu vực nhiệt độ ổn định | ≥800 mm |
| Độ chính xác của hệ thống điều khiển nhiệt độ | ±1°C |
| Kiểm soát hạt | 0,32 μm), 0,32 μm), 0,226 μm) |
| Độ dày màng | NIT1500 ±50 Å |
| Tính đồng nhất | Trong cùng một tấm wafer <2.5%, giữa các tấm wafer <2.5%, giữa các lô <2% |
Đặc điểm sản phẩm
- Việc xử lý tấm wafer tự động đảm bảo mức độ an toàn cao và hiệu quả vận hành.
- Buồng xử lý siêu sạch giúp giảm thiểu nguy cơ nhiễm bẩn và duy trì chất lượng màng ổn định.
- Độ đồng đều về độ dày màng cao giúp hỗ trợ quá trình sản xuất các nút công nghệ tiên tiến.
- Chức năng điều khiển nhiệt độ và áp suất thông minh theo thời gian thực cho phép điều chỉnh quy trình một cách chính xác.
- Giá đỡ tấm wafer SiC giúp giảm ma sát và sự hình thành các hạt bụi, từ đó kéo dài tuổi thọ của tấm wafer.
- Thiết kế mô-đun cho phép tùy chỉnh để phù hợp với các ứng dụng và nhu cầu quy trình đa dạng.
Nguyên lý của quá trình lắng đọng
- Giới thiệu về khí: Các khí phản ứng được đưa vào ống trong điều kiện áp suất thấp (0,25–1 Torr).
- Sự khuếch tán bề mặt: Các phân tử khuếch tán tự do trên bề mặt tấm wafer, đảm bảo độ phủ đồng đều.
- Hấp phụ: Các chất phản ứng bám dính vào bề mặt tấm wafer trước khi xảy ra phản ứng hóa học.
- Phản ứng hóa học: Quá trình phân hủy nhiệt tạo ra lớp màng mỏng mong muốn trực tiếp trên chất nền.
- Loại bỏ sản phẩm phụ: Các khí không phản ứng được hút hết ra ngoài để duy trì độ tinh khiết và ngăn ngừa sự can thiệp.
- Quá trình hình thành màng: Các sản phẩm phản ứng dần dần tích tụ lại, tạo thành một lớp màng mỏng đồng nhất và ổn định.
Ứng dụng
- Lớp oxit cách điện: Bảo vệ các tấm silicon khỏi bị nhiễm bẩn và giảm hiện tượng dẫn ion trong quá trình pha tạp.

- Lớp oxit pad: Hoạt động như một lớp đệm chống ứng suất giữa các lớp silicon và nitrit silicon, giúp ngăn ngừa hiện tượng nứt tấm wafer và nâng cao hiệu suất sản xuất.

- Lớp oxit cổng: Tạo thành lớp điện môi trong các cấu trúc MOS, đảm bảo sự dẫn điện chính xác và kiểm soát hiệu ứng trường.

Cấu hình hệ thống
- LPCVD theo phương thẳng đứng: Khí xử lý chảy từ trên xuống dưới, giúp đảm bảo lớp phủ đồng đều trên tất cả các tấm wafer trong một mẻ.

- LPCVD ngang: Khí lưu chuyển dọc theo chiều dài của các tấm nền, phù hợp cho sản xuất liên tục với khối lượng lớn, mặc dù độ dày lớp lắng đọng có thể thay đổi nhẹ ở khu vực gần phía đầu vào.

Câu hỏi thường gặp
Câu hỏi 1: LPCVD chủ yếu được sử dụng để làm gì?
A: LPCVD là một quy trình lắng đọng màng mỏng áp suất thấp được sử dụng rộng rãi trong sản xuất bán dẫn để lắng đọng polysilicon, nitrua silic và oxit silic, giúp tạo ra các lớp màng đồng đều và chất lượng cao phục vụ cho việc chế tạo các thiết bị tiên tiến.
Câu hỏi 2: LPCVD khác với PECVD như thế nào?
A: Phương pháp LPCVD dựa vào quá trình kích hoạt nhiệt ở áp suất thấp để tạo ra các lớp màng có độ tinh khiết cao, trong khi phương pháp PECVD sử dụng plasma ở nhiệt độ thấp hơn để tăng tốc độ lắng đọng, nhưng chất lượng lớp màng thường thấp hơn một chút.
Câu hỏi 3: Các kích thước và vật liệu wafer nào tương thích với lò oxy hóa LPCVD này?
A: Lò nung này hỗ trợ các tấm wafer có kích thước 6 inch, 8 inch và 12 inch, đồng thời tương thích với các loại tấm wafer polysilicon, nitrua silic, oxit silic và SiC, mang lại sự linh hoạt cho nhiều ứng dụng bán dẫn khác nhau.
Câu hỏi 4: Lò oxy hóa LPCVD có thể được tùy chỉnh cho các quy trình cụ thể không?
A: Đúng vậy, hệ thống này cung cấp các cấu hình mô-đun, bao gồm các vùng nhiệt độ có thể điều chỉnh, điều khiển lưu lượng khí và các chế độ oxy hóa (khô hoặc ướt), giúp đáp ứng các yêu cầu quy trình đa dạng cho cả nghiên cứu và sản xuất quy mô công nghiệp.







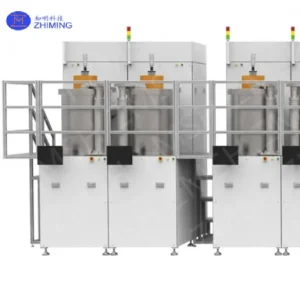
Đánh giá
Chưa có đánh giá nào.