Окислительная печь LPCVD 6/8/12-Inch - это современный инструмент для производства полупроводников, предназначенный для точного и равномерного осаждения тонких пленок. Она широко применяется для выращивания высококачественных слоев поликремния, нитрида кремния и оксида кремния на пластинах, обеспечивая стабильную производительность для силовых полупроводников, современных подложек и других высокоточных приложений.
Это оборудование сочетает в себе передовую технологию осаждения при низком давлении, интеллектуальный контроль температуры и сверхчистую технологическую схему, что позволяет добиться исключительной однородности тонких пленок и высокой производительности. Вертикальная конфигурация реактора обеспечивает эффективную пакетную обработку, а процесс термического осаждения позволяет избежать повреждений, вызванных плазмой, что делает его идеальным для таких критически важных процессов, как формирование диэлектрика затвора, буферных слоев и защитных оксидов.

Ключевые преимущества
- Осаждение тонких пленок с высокой степенью равномерности: Среда с низким давлением (0,1-10 Торр) обеспечивает однородность между пластинами и внутри пластин ±1,5%, что очень важно для производства высокопроизводительных устройств.
- Конструкция вертикального реактора: Обрабатывает 150-200 пластин за партию, повышая производительность и эффективность производства в промышленных масштабах для изготовления полупроводников.
- Процесс термического осаждения (500-900°C): Обеспечивает щадящее осаждение без плазмы для защиты чувствительных подложек и сохранения высокого качества пленки.
- Интеллектуальный контроль температуры: Контроль и регулировка в реальном времени с точностью ±1°C для получения стабильных, воспроизводимых результатов.
- Сверхчистая технологическая камера: Минимизирует загрязнение частицами, поддерживая SiC и другие современные материалы подложек.
- Настраиваемая конфигурация: Гибкая конструкция позволяет выполнять различные технологические требования, включая сухое или мокрое окисление и различные размеры пластин.
Технические характеристики
| Характеристика | Технические характеристики |
|---|---|
| Размер пластины | 6/8/12 дюйма |
| Совместимые материалы | Поликремний, нитрид кремния, оксид кремния |
| Тип окисления | Сухой кислород / влажный кислород (DCE, HCL) |
| Диапазон температуры процесса | 500°C-900°C |
| Зона постоянной температуры | ≥800 мм |
| Точность контроля температуры | ±1°C |
| Контроль частиц | 0,32 мкм), 0,32 мкм), 0,226 мкм) |
| Толщина пленки | NIT1500 ±50 Å |
| Равномерность | В пределах пластины <2,5%, от пластины к пластине <2,5%, от партии к партии <2% |
Характеристики товара
- Автоматизированная обработка пластин обеспечивает высокую безопасность и эффективность работы.
- Сверхчистая технологическая камера снижает риск загрязнения и поддерживает стабильное качество пленки.
- Превосходная однородность толщины пленки поддерживает передовое производство узлов.
- Интеллектуальный контроль температуры и давления в режиме реального времени позволяет точно регулировать процесс.
- Опора для пластин из SiC снижает трение и образование частиц, продлевая срок службы пластин.
- Модульная конструкция обеспечивает возможность настройки под различные задачи и технологические потребности.
Принцип процесса осаждения
- Газовое введение: Реакционные газы вводятся в трубку при низком давлении (0,25-1 Торр).
- Поверхностная диффузия: Молекулы свободно диффундируют по поверхности пластины, обеспечивая равномерное покрытие.
- Адсорбция: Реактивы прилипают к поверхности пластины до начала химической реакции.
- Химическая реакция: Термическое разложение формирует желаемую тонкую пленку непосредственно на подложке.
- Удаление побочных продуктов: Для сохранения чистоты и предотвращения помех нереактивные газы откачиваются.
- Формирование фильма: Продукты реакции постепенно накапливаются, образуя равномерный, устойчивый тонкопленочный слой.
Приложения
- Экранирующий оксидный слой: Защищает кремниевые пластины от загрязнения и уменьшает ионные каналы во время процессов легирования.

- Оксидный слой: Действует как буфер напряжения между слоями кремния и нитрида кремния, предотвращая растрескивание пластин и повышая их выход.

- Оксидный слой затвора: Обеспечивает диэлектрический слой в МОП-структурах, обеспечивая точную проводимость тока и управление полевым эффектом.

Конфигурации системы
- Вертикальный LPCVD: Технологические газы подаются сверху вниз, обеспечивая равномерное осаждение на всех пластинах в партии.

- Горизонтальный LPCVD: Газы текут по всей длине подложек, что подходит для непрерывного крупносерийного производства, хотя толщина осаждения может немного изменяться вблизи входной стороны.

Часто задаваемые вопросы
Q1: Для чего в основном используется LPCVD?
О: LPCVD - это процесс тонкопленочного осаждения под низким давлением, широко используемый в производстве полупроводников для осаждения поликремния, нитрида кремния и оксида кремния, что позволяет получать однородные и высококачественные пленки для изготовления современных устройств.
Вопрос 2: Чем LPCVD отличается от PECVD?
О: LPCVD основан на термической активации при низком давлении для получения высокочистых пленок, в то время как PECVD использует плазму при более низких температурах для более быстрого осаждения, часто с несколько более низким качеством пленки.
Q3: Какие размеры пластин и материалы совместимы с этой печью для окисления LPCVD?
О: Эта печь поддерживает 6-, 8- и 12-дюймовые пластины и совместима с пластинами из поликремния, нитрида кремния, оксида кремния и SiC, обеспечивая гибкость для различных полупроводниковых приложений.
Q4: Может ли печь для окисления LPCVD быть настроена для конкретных процессов?
О: Да, система предлагает модульные конфигурации, включая регулируемые температурные зоны, управление потоком газа и режимы окисления (сухое или мокрое), что позволяет удовлетворить различные технологические требования как для исследований, так и для промышленного производства.






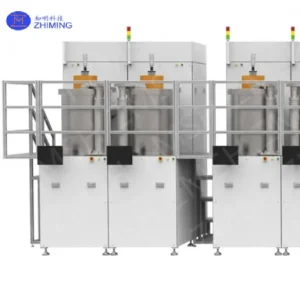
Отзывы
Отзывов пока нет.