6/8/12-calowy piec do utleniania LPCVD to najnowocześniejsze narzędzie do produkcji półprzewodników, zaprojektowane do precyzyjnego i jednolitego osadzania cienkich warstw. Jest szeroko stosowany do wytwarzania wysokiej jakości warstw polikrzemu, azotku krzemu i tlenku krzemu na waflach, zapewniając stałą wydajność półprzewodników mocy, zaawansowanych podłoży i innych precyzyjnych zastosowań.
Sprzęt ten łączy w sobie zaawansowaną technologię osadzania niskociśnieniowego, inteligentną kontrolę temperatury i ultra-czystą konstrukcję procesu, aby osiągnąć wyjątkową jednorodność cienkiej warstwy i wysoką przepustowość. Pionowa konfiguracja reaktora umożliwia wydajne przetwarzanie wsadowe, a proces osadzania termicznego pozwala uniknąć uszkodzeń spowodowanych plazmą, dzięki czemu idealnie nadaje się do krytycznych procesów, takich jak tworzenie dielektryków bramek, warstw buforujących naprężenia i tlenków ochronnych.

Główne zalety
- Wysoka jednorodność osadzania cienkowarstwowego: Środowisko o niskim ciśnieniu (0,1-10 Torr) zapewnia jednorodność między waflami i w obrębie wafli ±1,5%, co ma kluczowe znaczenie dla wysokowydajnej produkcji urządzeń.
- Konstrukcja reaktora pionowego: Obsługuje 150-200 płytek na partię, poprawiając przepustowość i wydajność produkcji półprzewodników na skalę przemysłową.
- Proces osadzania termicznego (500-900°C): Zapewnia delikatne, wolne od plazmy osadzanie w celu ochrony wrażliwych podłoży i utrzymania wysokiej jakości folii.
- Inteligentna kontrola temperatury: Monitorowanie i regulacja w czasie rzeczywistym z dokładnością ±1°C zapewnia stabilne, powtarzalne wyniki.
- Ultra czysta komora procesowa: Minimalizuje zanieczyszczenie cząsteczkami, wspierając SiC i inne zaawansowane materiały waflowe.
- Możliwość dostosowania konfiguracji: Elastyczna konstrukcja spełnia różne wymagania procesowe, w tym utlenianie na sucho lub mokro oraz różne rozmiary płytek.
Specyfikacja techniczna
| Cecha | Specyfikacja |
|---|---|
| Rozmiar wafla | 6/8/12 Cal |
| Kompatybilne materiały | Polikrzem, azotek krzemu, tlenek krzemu |
| Typ utleniania | Suchy tlen / mokry tlen (DCE, HCL) |
| Zakres temperatury procesu | 500°C-900°C |
| Strefa stałej temperatury | ≥800 mm |
| Dokładność kontroli temperatury | ±1°C |
| Kontrola cząstek | 0,32 μm), 0,32 μm), 0,226 μm) |
| Grubość folii | NIT1500 ±50 Å |
| Jednolitość | W obrębie wafla <2,5%, między waflami <2,5%, między partiami <2% |
Cechy produktu
- Zautomatyzowana obsługa wafli zapewnia wysokie bezpieczeństwo i wydajność operacyjną.
- Ultra czysta komora procesowa zmniejsza ryzyko zanieczyszczenia i utrzymuje stałą jakość folii.
- Doskonała jednorodność grubości powłoki wspiera zaawansowaną produkcję węzłów.
- Inteligentna kontrola temperatury i ciśnienia w czasie rzeczywistym umożliwia precyzyjną regulację procesu.
- Wspornik wafla SiC zmniejsza tarcie i generowanie cząstek, wydłużając żywotność wafla.
- Modułowa konstrukcja umożliwia dostosowanie do różnych zastosowań i potrzeb procesowych.
Zasada procesu osadzania
- Wprowadzenie do gazu: Gazy reakcyjne są wprowadzane do rury w warunkach niskiego ciśnienia (0,25-1 Torr).
- Dyfuzja powierzchniowa: Cząsteczki swobodnie dyfundują po powierzchni wafla, zapewniając jednolite pokrycie.
- Adsorpcja: Reagenty przylegają do powierzchni płytki przed reakcją chemiczną.
- Reakcja chemiczna: Rozkład termiczny tworzy pożądaną cienką warstwę bezpośrednio na podłożu.
- Usuwanie produktów ubocznych: Gazy niereaktywne są odprowadzane, aby zachować czystość i zapobiec zakłóceniom.
- Formacja filmowa: Produkty reakcji stopniowo gromadzą się, tworząc jednolitą, stabilną warstwę cienkowarstwową.
Zastosowania
- Ekranująca warstwa tlenkowa: Chroni wafle krzemowe przed zanieczyszczeniem i zmniejsza kanałowanie jonów podczas procesów domieszkowania.

- Warstwa Pad Oxide: Działa jako bufor naprężeń między warstwami krzemu i azotku krzemu, zapobiegając pękaniu płytek i poprawiając wydajność.

- Warstwa tlenku bramy: Stanowi warstwę dielektryczną w strukturach MOS, zapewniając precyzyjne przewodzenie prądu i kontrolę efektu polowego.

Konfiguracje systemu
- Pionowe LPCVD: Gazy procesowe przepływają od góry do dołu, zapewniając równomierne osadzanie na wszystkich waflach w partii.

- Poziome LPCVD: Gazy przepływają wzdłuż długości substratów, co nadaje się do ciągłej, wysokonakładowej produkcji, chociaż grubość osadzania może się nieznacznie różnić w pobliżu strony wlotowej.

Często zadawane pytania
P1: Do czego głównie wykorzystywana jest technologia LPCVD?
O: LPCVD to niskociśnieniowy proces osadzania cienkich warstw szeroko stosowany w produkcji półprzewodników do osadzania polikrzemu, azotku krzemu i tlenku krzemu, umożliwiający tworzenie jednolitych i wysokiej jakości warstw do produkcji zaawansowanych urządzeń.
P2: Czym różni się LPCVD od PECVD?
O: LPCVD opiera się na aktywacji termicznej pod niskim ciśnieniem w celu wytworzenia folii o wysokiej czystości, podczas gdy PECVD wykorzystuje plazmę w niższych temperaturach do szybszego osadzania, często przy nieco niższej jakości folii.
P3: Jakie rozmiary płytek i materiały są kompatybilne z tym piecem do utleniania LPCVD?
O: Ten piec obsługuje 6-, 8- i 12-calowe wafle i jest kompatybilny z polikrzemem, azotkiem krzemu, tlenkiem krzemu i waflami SiC, zapewniając elastyczność w różnych zastosowaniach półprzewodnikowych.
P4: Czy piec do utleniania LPCVD można dostosować do określonych procesów?
O: Tak, system oferuje modułowe konfiguracje, w tym regulowane strefy temperatury, kontrolę przepływu gazu i tryby utleniania (na sucho lub mokro), dzięki czemu może spełniać różnorodne wymagania procesowe zarówno w badaniach, jak i produkcji na skalę przemysłową.






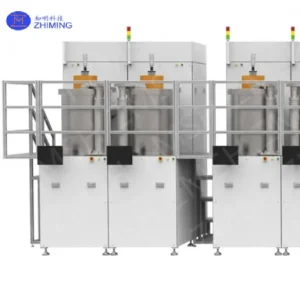
Opinie
Na razie nie ma opinii o produkcie.