![]() The HP-1221 Fully Automatic Wafer Dicing Machine is a high-efficiency, precision-engineered solution designed for semiconductor wafer singulation processes. Supporting wafers up to 12 inches (300 mm), this system integrates advanced automation, dual-spindle cutting technology, and intelligent alignment systems to deliver superior cutting accuracy, throughput, and consistency.
The HP-1221 Fully Automatic Wafer Dicing Machine is a high-efficiency, precision-engineered solution designed for semiconductor wafer singulation processes. Supporting wafers up to 12 inches (300 mm), this system integrates advanced automation, dual-spindle cutting technology, and intelligent alignment systems to deliver superior cutting accuracy, throughput, and consistency.
Engineered for modern semiconductor manufacturing environments, the HP-1221 enables a fully automated workflow—from wafer loading and alignment to precision dicing, followed by integrated cleaning and drying. This significantly reduces manual intervention, improves yield, and ensures repeatable process stability.
With its compact footprint and robust structural design, the HP-1221 is suitable for both high-volume production lines and specialized applications requiring high precision and reliability.
Key Features
1. Dual Spindle Opposed Structure for High Efficiency
The machine adopts an advanced opposed dual-spindle configuration. By reducing the distance between the two spindles, the system minimizes idle movement and significantly improves cutting efficiency. This design enables continuous operation and reduces cycle time, making it ideal for high-throughput production environments.
2. Fully Automated Integrated Process
The HP-1221 supports a complete automated process, including:
- Automatic wafer loading and unloading
- High-precision alignment
- Controlled dicing operation
- Integrated cleaning and drying
This level of automation not only enhances productivity but also reduces operator dependency and human-induced errors.
3. High-Precision Alignment and Inspection System
Equipped with a dual-microscope configuration (high and low magnification), the system ensures:
- Fast and accurate wafer alignment
- Real-time cutting path verification
- High-resolution kerf inspection
This feature is critical for maintaining tight tolerances and ensuring consistent cutting quality, especially for advanced semiconductor devices.
4. Sub-C/T Assisted Blade Dressing Function
The integrated Sub-C/T blade dressing function helps maintain optimal blade sharpness during operation. This results in:
- Improved cutting surface quality
- Reduced chipping and micro-cracks
- Extended blade life
Ultimately, this contributes to lower operational costs and higher product yield.
5. Optional Two-Fluid Cleaning Nozzle
An optional air-water dual-fluid nozzle can be installed at the cutting area to enhance post-dicing cleaning performance. This ensures effective removal of debris and particles, improving wafer cleanliness and reducing contamination risks in downstream processes.
Technical Specifications
| Parameter | Specification |
|---|---|
| Spindle Power / Speed | 1.8 kW / 2.2 kW (Optional), 6000–60000 rpm |
| Flange Size | 2 inches |
| Maximum Workpiece Size | Round: Ø300 mm / Square: 254 mm × 254 mm |
| Microscope Configuration | High magnification: 7.5× / Low magnification: 0.75× (Optional) |
| Machine Dimensions (W × D × H) | 1285 mm × 1590 mm × 1860 mm |
Applications
The HP-1221 is designed to meet the demanding requirements of various semiconductor and advanced material applications, including:
- Silicon wafer dicing for integrated circuits (ICs)
- Power device wafer processing (e.g., SiC, GaN)
- MEMS device fabrication
- LED and optoelectronic wafer cutting
- Advanced packaging and wafer-level packaging processes
Its compatibility with wafers up to 12 inches makes it suitable for both mature and advanced fabrication nodes.
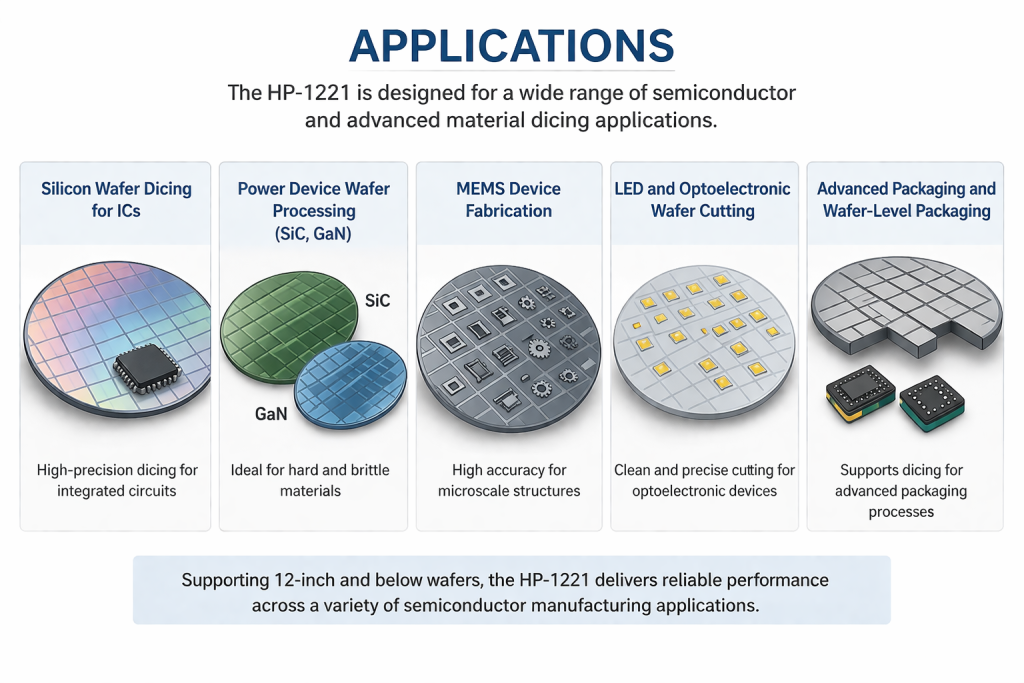
Performance Advantages
Improved Yield and Reliability
Precision alignment and stable spindle performance ensure minimal edge chipping and high-quality cut surfaces, directly contributing to improved device yield.
High Throughput
The dual-spindle design and reduced cycle time enable faster processing without compromising accuracy, making the system ideal for large-scale production.
Process Stability
Integrated automation and intelligent control systems ensure consistent performance across long production cycles, reducing variability and improving repeatability.
Cost Efficiency
Features such as blade dressing and efficient cleaning reduce consumable usage and maintenance frequency, lowering overall operational costs.
Why Choose HP-1221
The HP-1221 stands out as a reliable and scalable wafer dicing solution for manufacturers seeking:
- High precision in wafer singulation
- Automated, operator-independent processes
- Compatibility with advanced materials
- Long-term cost efficiency and stable performance
Its combination of advanced engineering, automation, and user-oriented design makes it a valuable addition to any semiconductor manufacturing line.
FAQ
1. What types of wafers can the HP-1221 process?
The HP-1221 is designed to handle a wide range of wafer materials used in semiconductor and advanced electronics manufacturing. These include silicon (Si), silicon carbide (SiC), gallium nitride (GaN), and other compound semiconductor materials.
With its high spindle speed (up to 60,000 rpm) and stable cutting performance, the system is capable of processing both standard and hard, brittle materials while maintaining excellent edge quality and minimal chipping.
2. How does the dual spindle system improve production efficiency?
The opposed dual spindle structure significantly reduces non-productive movement during operation. By minimizing the distance between cutting axes, the system can perform faster transitions and continuous cutting operations.
This results in:
- Shorter cycle times
- Higher throughput
- Improved equipment utilization
Compared to single-spindle systems, the HP-1221 offers a more efficient solution for high-volume wafer dicing applications.
3. How does the machine ensure cutting accuracy and quality?
The HP-1221 integrates multiple features to guarantee precision and consistency, including:
- Dual-microscope system for accurate alignment and real-time inspection
- High-speed, low-vibration spindle for stable cutting
- Sub-C/T blade dressing function to maintain blade sharpness
- Optional dual-fluid cleaning system to remove debris and prevent contamination
These combined technologies help ensure tight tolerances, clean kerf lines, and high repeatability, which are essential for maintaining yield in semiconductor manufacturing.




Reviews
There are no reviews yet.