![]() HP-1221 전자동 웨이퍼 다이싱 머신은 반도체 웨이퍼 싱글레이션 공정을 위해 설계된 고효율, 정밀 엔지니어링 솔루션입니다. 최대 12인치(300mm) 웨이퍼를 지원하는 이 시스템은 첨단 자동화, 이중 스핀들 절단 기술 및 지능형 정렬 시스템을 통합하여 탁월한 절단 정확도, 처리량 및 일관성을 제공합니다.
HP-1221 전자동 웨이퍼 다이싱 머신은 반도체 웨이퍼 싱글레이션 공정을 위해 설계된 고효율, 정밀 엔지니어링 솔루션입니다. 최대 12인치(300mm) 웨이퍼를 지원하는 이 시스템은 첨단 자동화, 이중 스핀들 절단 기술 및 지능형 정렬 시스템을 통합하여 탁월한 절단 정확도, 처리량 및 일관성을 제공합니다.
최신 반도체 제조 환경에 맞게 설계된 HP-1221은 웨이퍼 로딩 및 정렬부터 정밀 다이싱, 통합 세척 및 건조에 이르는 완전 자동화된 워크플로우를 지원합니다. 따라서 수동 개입이 크게 줄어들고 수율이 향상되며 반복 가능한 공정 안정성이 보장됩니다.
컴팩트한 설치 공간과 견고한 구조 설계를 갖춘 HP-1221은 대량 생산 라인과 높은 정밀도와 신뢰성이 요구되는 특수 애플리케이션 모두에 적합합니다.
주요 기능
1. 고효율을 위한 듀얼 스핀들 반대 구조
이 기계는 고급 반대쪽 듀얼 스핀들 구성을 채택하고 있습니다. 이 시스템은 두 스핀들 사이의 거리를 줄임으로써 유휴 움직임을 최소화하고 절단 효율을 크게 향상시킵니다. 이 설계는 연속 작동을 가능하게 하고 사이클 시간을 줄여주므로 처리량이 많은 생산 환경에 이상적입니다.
2. 완전 자동화된 통합 프로세스
HP-1221은 다음을 포함한 완전한 자동화 프로세스를 지원합니다:
- 자동 웨이퍼 로딩 및 언로딩
- 고정밀 정렬
- 제어된 다이싱 작업
- 통합 청소 및 건조
이러한 수준의 자동화는 생산성을 향상시킬 뿐만 아니라 작업자의 의존도와 인적 오류를 줄여줍니다.
3. 고정밀 정렬 및 검사 시스템
듀얼 현미경 구성(고배율 및 저배율)을 갖춘 이 시스템은 다음을 보장합니다:
- 빠르고 정확한 웨이퍼 정렬
- 실시간 절단 경로 확인
- 고해상도 커프 검사
이 기능은 특히 첨단 반도체 장치에서 엄격한 공차를 유지하고 일관된 절단 품질을 보장하는 데 매우 중요합니다.
4. 서브-C/T 보조 블레이드 드레싱 기능
통합된 Sub-C/T 칼날 드레싱 기능은 작동 중 최적의 칼날 선명도를 유지하는 데 도움이 됩니다. 그 결과
- 향상된 절단면 품질
- 칩핑 및 미세 균열 감소
- 연장된 블레이드 수명
이는 궁극적으로 운영 비용을 낮추고 제품 수율을 높이는 데 기여합니다.
5. 2액형 세척 노즐(옵션)
옵션으로 공기-물 이중 유체 노즐을 절단 영역에 설치하여 다이싱 후 세척 성능을 향상시킬 수 있습니다. 이를 통해 이물질과 입자를 효과적으로 제거하여 웨이퍼 청결도를 개선하고 다운스트림 공정의 오염 위험을 줄일 수 있습니다.
기술 사양
| 매개변수 | 사양 |
|---|---|
| 스핀들 출력/속도 | 1.8kW/2.2kW(옵션), 6000-60000rpm |
| 플랜지 크기 | 2인치 |
| 최대 공작물 크기 | 원형: Ø300mm / 정사각형: 254mm × 254mm |
| 현미경 구성 | 고배율: 7.5배 / 저배율: 0.75배 (옵션) |
| 기계 치수(W × D × H) | 1285mm × 1590mm × 1860mm |
애플리케이션
HP-1221은 다음과 같은 다양한 반도체 및 첨단 소재 애플리케이션의 까다로운 요구 사항을 충족하도록 설계되었습니다:
- 집적 회로(IC)용 실리콘 웨이퍼 다이싱
- 전력 소자 웨이퍼 처리(예: SiC, GaN)
- MEMS 디바이스 제작
- LED 및 광전자 웨이퍼 절단
- 고급 패키징 및 웨이퍼 레벨 패키징 프로세스
최대 12인치 웨이퍼와 호환되므로 성숙 노드와 고급 제조 노드 모두에 적합합니다.
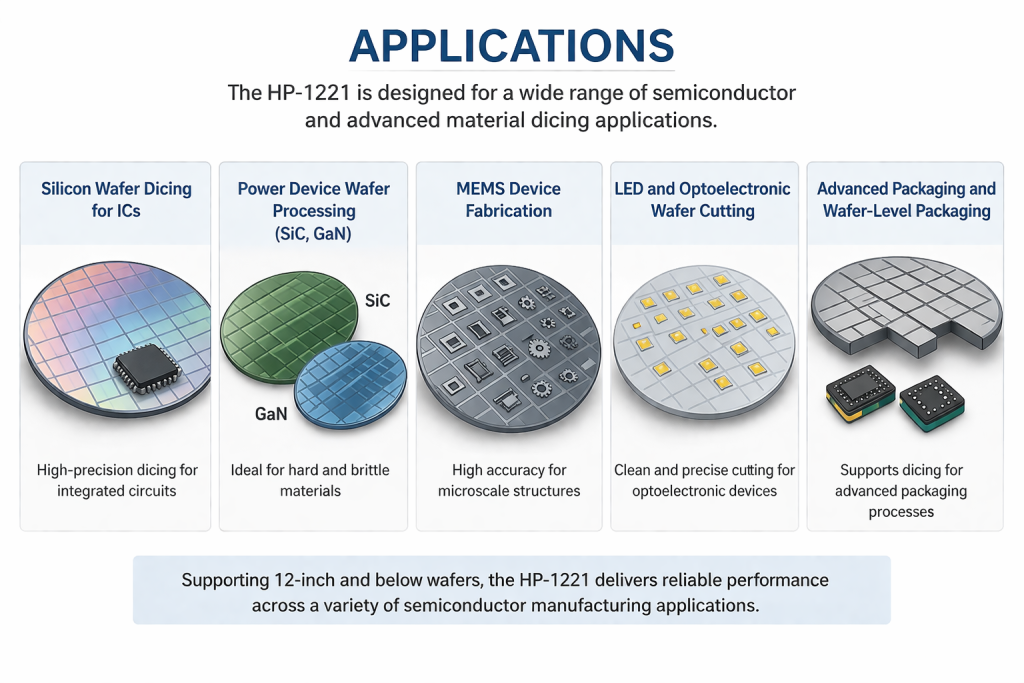
성능 이점
수율 및 안정성 향상
정밀한 정렬과 안정적인 스핀들 성능으로 가장자리 칩핑을 최소화하고 고품질 절단 표면을 보장하여 디바이스 수율 향상에 직접적으로 기여합니다.
높은 처리량
듀얼 스핀들 설계와 사이클 시간 단축으로 정확도 저하 없이 더 빠르게 처리할 수 있어 대규모 생산에 이상적인 시스템입니다.
프로세스 안정성
통합 자동화 및 지능형 제어 시스템은 긴 생산 주기 동안 일관된 성능을 보장하여 변동성을 줄이고 반복성을 개선합니다.
비용 효율성
칼날 드레싱 및 효율적인 세척과 같은 기능은 소모품 사용량과 유지보수 빈도를 줄여 전체 운영 비용을 낮춥니다.
HP-1221을 선택해야 하는 이유
HP-1221은 제조업체가 원하는 안정적이고 확장 가능한 웨이퍼 다이싱 솔루션으로 돋보입니다:
- 웨이퍼 싱귤레이션의 높은 정밀도
- 운영자와 독립적인 자동화된 프로세스
- 고급 소재와의 호환성
- 장기적인 비용 효율성과 안정적인 성능
첨단 엔지니어링, 자동화, 사용자 중심의 설계가 결합된 이 제품은 모든 반도체 제조 라인에 유용하게 사용할 수 있습니다.
자주 묻는 질문
1. HP-1221은 어떤 유형의 웨이퍼를 처리할 수 있습니까?
HP-1221은 반도체 및 첨단 전자 제품 제조에 사용되는 다양한 웨이퍼 재료를 처리하도록 설계되었습니다. 여기에는 실리콘(Si), 실리콘 카바이드(SiC), 질화 갈륨(GaN) 및 기타 화합물 반도체 재료가 포함됩니다.
이 시스템은 높은 스핀들 속도(최대 60,000rpm)와 안정적인 절삭 성능으로 표준 소재와 단단하고 부서지기 쉬운 소재를 모두 가공할 수 있으며 우수한 모서리 품질과 최소한의 칩핑을 유지합니다.
2. 듀얼 스핀들 시스템은 생산 효율성을 어떻게 개선하나요?
반대되는 이중 스핀들 구조는 작동 중 비생산적인 움직임을 크게 줄여줍니다. 절단 축 사이의 거리를 최소화함으로써 시스템은 더 빠른 전환과 연속 절단 작업을 수행할 수 있습니다.
그 결과
- 주기 시간 단축
- 더 높은 처리량
- 장비 활용도 향상
단일 스핀들 시스템에 비해 HP-1221은 대량 웨이퍼 다이싱 애플리케이션에 더 효율적인 솔루션을 제공합니다.
3. 기계는 절단 정확도와 품질을 어떻게 보장하나요?
HP-1221은 다음과 같은 다양한 기능을 통합하여 정확성과 일관성을 보장합니다:
- 정확한 정렬과 실시간 검사를 위한 듀얼 현미경 시스템
- 안정적인 절단을 위한 고속, 저진동 스핀들
- Sub-C/T 블레이드 드레싱 기능으로 칼날 선명도 유지
- 이물질을 제거하고 오염을 방지하는 이중 유체 세척 시스템(옵션)
이러한 결합된 기술은 반도체 제조에서 수율을 유지하는 데 필수적인 엄격한 공차, 깨끗한 커프 라인, 높은 반복성을 보장합니다.



상품평
아직 상품평이 없습니다.