제품 개요
세척 및 재장착 루프를 갖춘 6-8인치 실리콘 및 SiC 웨이퍼 쿼드 폴리싱 자동화 라인은 실리콘 및 실리콘 카바이드 웨이퍼의 대량 생산을 지원하도록 설계된 완전 통합형 후연마 공정 플랫폼입니다.
이 시스템은 쿼드 헤드 연마, 자동 웨이퍼 디마운팅, 세라믹 캐리어 처리, 캐리어 세척, 정밀 웨이퍼 재장착을 연속 폐쇄 루프 흐름으로 연결하여 수작업을 없애고 공정 안정성, 반복성 및 수율을 극대화합니다.
평탄도, 표면 무결성 및 오염 제어가 중요한 전력 반도체 웨이퍼, SiC 기판 및 고급 패키징 애플리케이션에 최적화되어 있습니다.

폐쇄 루프 프로세스 개념
기존의 반수동 연마 라인과 달리 이 시스템은 진정한 폐쇄 루프 캐리어 주기로 작동합니다:
폴리싱 → 장착 해제 → 캐리어 청소 → 재장착 → 폴리싱
세라믹 캐리어가 시스템 내부를 자동으로 순환하는 동안 웨이퍼는 엄격하게 제어된 조건에서 정밀하게 제거되고 다시 장착됩니다.
이 아키텍처는 모든 폴리싱 주기가 시작될 때 다음과 같이 시작됩니다:
-
깨끗한 캐리어 표면
-
정밀하게 배치된 웨이퍼
-
안정적이고 반복 가능한 마운팅 인터페이스
그 결과 웨이퍼 파손이 감소하고 두께 균일성이 향상되며 배치 간 일관성이 높아집니다.
![]()
프로세스 크리티컬 엔지니어링 설계
저응력 웨이퍼 처리
특수 모션 프로파일과 탈착 궤적을 사용하여 가속도, 접촉력 및 분리 각도를 제어하여 감소시킵니다:
-
엣지 치핑
-
미세 균열
-
응력에 의한 웨이퍼 휨
이는 단단하고 부서지기 쉬우며 기계적 충격에 매우 민감한 SiC 웨이퍼에 특히 중요합니다.
초청정 캐리어 리컨디셔닝
각 재장착 주기 전에 세라믹 캐리어는 슬러리 잔여물, 미세 입자 및 화학 필름을 제거하여 공정에 적합한 표면 상태로 복원합니다.
이를 방지합니다:
-
입자로 인한 스크래치
-
로컬 폴리싱 불균일성
-
무작위 표면 결함
CMP 및 쿼드 폴리싱 작업의 주요 수율 킬러입니다.
균일한 연마를 위한 정밀 리마운팅
다시 장착 장치 제어:
-
장착 압력
-
웨이퍼 정렬
-
전체 캐리어에 걸친 평탄도
이는 다음 쿼드 폴리싱 사이클 동안 모든 웨이퍼가 균일한 연마 압력을 경험하도록 보장합니다:
-
개선된 TTV(총 두께 변화)
-
표면 거칠기 개선
-
더 높은 가용 웨이퍼 수율
프로덕션 유연성
이 시스템은 여러 웨이퍼 및 캐리어 구성을 지원하므로 팹에서 라인을 조정할 수 있습니다:
-
최대 처리량
-
최대 평탄도 제어
-
6인치 및 8인치 혼합 제작
따라서 이 라인은 두 가지 모두에 적합합니다:
-
대용량 전력 디바이스 생산
-
고부가가치 SiC 기판 처리
일반적인 애플리케이션
-
Si 및 SiC 전력 반도체 웨이퍼(MOSFET, IGBT, 다이오드)
-
SiC 기판 및 에피택셜 웨이퍼
-
고급 패키징 웨이퍼
-
고정밀 폴리싱 실리콘 웨이퍼
FAQ - 추가 기술 관련 질문
Q1: 이 시스템은 깨지기 쉬운 SiC 웨이퍼의 웨이퍼 파손을 어떻게 최소화하나요?
이 라인은 저응력 디마운팅 알고리즘과 제어된 모션 프로파일을 사용하여 가속도, 분리 각도 및 접촉력을 세심하게 관리합니다. 이를 통해 SiC 기판의 일반적인 문제인 에지 칩핑, 미세 균열, 응력으로 인한 웨이퍼 휨을 방지합니다.
Q2: 청소 및 재장착 루프가 여러 캐리어 사양을 처리할 수 있나요?
예. 캐리어 버퍼 및 클리닝 모듈은 다양한 세라믹 캐리어 직경(예: 485mm 및 576mm)과 캐리어당 웨이퍼 수를 지원합니다. 따라서 라인 중단 없이 혼합 크기의 6인치 및 8인치 웨이퍼를 생산할 수 있습니다.
Q3: 시스템은 배치 전반에 걸쳐 반복 가능한 폴리싱 품질을 어떻게 보장하나요?
매우 깨끗한 캐리어 표면, 정밀한 웨이퍼 정렬 및 평탄도 제어를 결합하여 각 웨이퍼는 동일한 조건에서 실장됩니다. 이를 통해 일관된 연마 압력, 균일한 재료 제거, 최소한의 TTV를 보장하여 생산 배치 전반에 걸쳐 안정적인 수율과 표면 품질을 제공합니다.




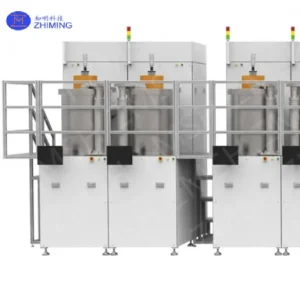
상품평
아직 상품평이 없습니다.