製品概要
洗浄・再マウントループ付き6-8インチシリコン&SiCウェーハ・クワッド・ポリッシング自動化ラインは、シリコンおよび炭化ケイ素ウェーハの大量生産をサポートするために設計された、完全に統合されたポストポリッシング・プロセス・プラットフォームです。.
このシステムは、クワッドヘッドポリッシング、自動ウェーハデマウント、セラミックキャリアハンドリング、キャリア洗浄、精密ウェーハ再マウントを連続的なクローズドループフローに接続し、手作業を排除し、プロセスの安定性、再現性、歩留まりを最大限に確保します。.
パワー半導体ウェハー、SiC基板、および平坦性、表面整合性、汚染管理が重要な先端パッケージング用途に最適化されている。.

クローズド・ループ・プロセスのコンセプト
従来の半手動の研磨ラインとは異なり、このシステムは真のクローズドループ・キャリアサイクルとして作動します:
研磨 → 脱着 → キャリア洗浄 → 再装着 → 研磨
セラミック・キャリアは自動的にシステム内を循環し、ウェーハは厳密に制御された条件下で正確に取り出され、再マウントされる。.
このアーキテクチャは、すべての研磨サイクルが最初に開始されることを保証する:
-
きれいなキャリア表面
-
正確に位置決めされたウェハ
-
安定した再現性のある取り付けインターフェース
その結果、ウェハーの破損が減少し、厚さの均一性が向上し、バッチ間の一貫性が高まった。.
![]()
プロセス・クリティカル・エンジニアリング設計
低ストレスウェハーハンドリング
加速度、接触力、分離角を制御するために、特殊なモーションプロファイルとデマウント軌道が使用される:
-
エッジ・チッピング
-
マイクロクラック
-
応力によるウェハ反り
これは、硬くて脆く、機械的衝撃に非常に敏感なSiCウェハーにとって特に重要である。.
超クリーン・キャリア再生
各再装着サイクルの前に、セラミックキャリアは、スラリー残渣、微粒子、化学膜を除去することにより、加工可能な表面状態に復元されます。.
これによって防げる:
-
粒子による傷
-
局所研磨の不均一性
-
ランダムな表面欠陥
これはCMPや四重研磨の歩留まりを大きく低下させる。.
均一な研磨のための精密再マウント
再装着ユニットが制御する:
-
取り付け圧力
-
ウェハーアライメント
-
キャリア全体の平坦性
これにより、次の4回研磨サイクルでは、すべてのウェーハが均一な研磨圧力を受けることが保証されます:
-
TTV(総厚みばらつき)の改善
-
表面粗さの向上
-
使用可能なウェーハの歩留まりの向上
生産の柔軟性
このシステムは、複数のウェハとキャリアのコンフィギュレーションをサポートし、工場がラインを調整することを可能にする:
-
最大スループット
-
最大限の平面度コントロール
-
6インチと8インチの混合生産
そのため、このラインはどちらにも適している:
-
パワーデバイスの大量生産
-
高付加価値SiC基板加工
代表的なアプリケーション
-
SiおよびSiCパワー半導体ウェハー(MOSFET、IGBT、ダイオード)
-
SiC基板およびエピタキシャルウエハー
-
アドバンスト・パッケージング・ウェーハ
-
高精度研磨シリコンウェーハ
FAQ - その他の技術的な質問
Q1: 脆いSiCウェーハの破損をどのように最小限に抑えるのですか?
このラインでは、低ストレスデマウントアルゴリズムと制御されたモーションプロファイルを使用し、加速度、分離角度、接触力を慎重に管理しています。これにより、SiC基板の一般的な問題であるエッジのチッピング、マイクロクラック、応力によるウェーハの反りを防止します。.
Q2: クリーニングと再装着ループは複数のキャリア仕様に対応できますか?
キャリアバッファと洗浄モジュールは、複数のセラミックキャリア径(例:485 mmと576 mm)とキャリアあたりのウェーハ枚数に対応しています。これにより、ラインを中断することなく、6インチと8インチのウェーハを混在して生産することができます。.
Q3: バッチ間で再現可能な研磨品質を保証するシステムはどのようになっていますか?
超清浄なキャリア表面、精密なウェーハアライメント、平面度制御を組み合わせることで、各ウェーハは同一条件下でマウントされます。これにより、一貫した研磨圧力、均一な材料除去、最小限のTTVが保証され、生産バッチ全体にわたって安定した歩留まりと表面品質が得られます。.




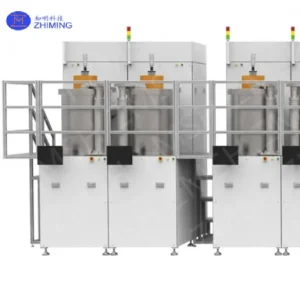
レビュー
レビューはまだありません。